
Рис.
1 Дендриты на поверхности печатной платы, возникшие между двумя проводниками
вследствие электромиграционного переноса меди
Технические науки/6. Электротехника и радиоэлектроника.
К.т.н. Архипов А.В., Архипов А.А.
Самарский государственный аэрокосмический
университет имени академика С.П.Королёва (национальный исследовательский
университет) Россия
Стенд для исследования электромиграции в паяных
контактах печатных узлов РЭС
Электромиграция явление переноса вещества в проводнике за
счет постепенного дрейфа ионов, возникающее благодаря обмену количеством
движения при столкновениях между проводящими носителями и атомной решеткой. Этот
эффект играет существенную роль в тех прикладных областях, где возникают токи
большой плотности, например в микроэлектронике. Размеры компонентов
радиоэлектронных средств (РЭС) в настоящее время таковы, что данная проблема не
может не проявиться в печатных узлах РЭС (рис 1[1]).

Рис.
1 Дендриты на поверхности печатной платы, возникшие между двумя проводниками
вследствие электромиграционного переноса меди
Из-за переноса ионов металла, в проводниках появляются
обедненные веществом зоны, сопротивление и плотность тока в этих зонах
существенно возрастают. Это приводит к еще большему нагреву проводника и к
дальнейшему усилению электромиграции. Данный процесс приводит к частичному или
полному разрушению проводника либо под действием температуры, либо из-за полного
истощения металла. С другой стороны, скопившееся вещество может сформировать
новое непреднамеренное соединение, что может привести к снижению
производительности схемы или к короткому замыканию (рис. 2 [2]).
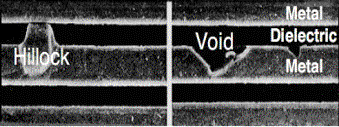
Рис.
2 Накопление и истощение металла вследствие электро-миграционной деградации про-водников
В связи с существенной миниатюризацией
компонентов и с увеличением доли бессвинцовых сплавов при монтаже печатных
узлов (ПУ), в результате применения которых растет пористость паяных контактов,
существует настоятельная потребность исследования процессов электромиграции в
контактах ПУ. Для получения требуемых параметров электромиграционной деградации
предлагается провести эксперимент, в котором сформировать тестовые ПУ из микроминиатюрных
компонентов РЭС, собранных по технологии поверхностного монтажа и с применением
различных марок припоев.
Провести исследование сформированных контактов с
помощью рентгенотомографии, что позволит выявить технологически сформированные
поры в паяных контактах и их размеры (рис. 3 [3]).
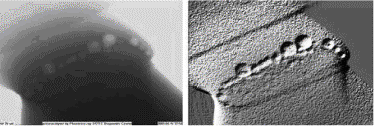
Рис. 3 Поры в паяных контактах выявленных при
рентгеновском исследовании
Подать на тестовый ПУ
ток большой плотности и исследовать процессы развития дефектов паяных контактов
при различных условиях, осуществляя контроль температуры и времени, что
позволит с учетом процессов самодиффузии оценить параметры процесса
электромиграции.
Для реализации
эксперимента был разработан и изготовлен испытательный стенд, схема которого
приведена на рис.4.

Рис. 4 Испытательный стенд
Он будет состоять из следующих элементов:
1. Регулируемый источник
тока, позволяющий обеспечивать плотности тока близкие к критическим в области
паяных контактов;
2. Тестовый ПУ, на котором
в качестве компонентов установлен набор SMD перемычек, обладающих
практически нулевым сопротивлением;
3. Термостабилизирующий
элемент, в виде трансформаторного масла с системой охлаждения, предотвращающий
неравномерный локальный перегрев в зонах максимальной плотности тока.
4. Приборы, автоматически
регистрирующие силу тока, температуру и время проведения эксперимента.
5. Исследуемый ПУ,
представляющий собой простейший тестовый узел как на рис. 5.

Рис. 5 Примерный вид исследуемого ПУ. Проводники
выполнены в виде широких полос фольги для снижения токовой нагрузки, которая
сосредоточится в основном на паяных контакта SMD-перемычек.
В процессе проведения эксперимента необходимо
контролировать развитие пор вплоть до предполагаемого образования микротрещин,
которые приведут к обрыву контактов. Это позволит определить временные
параметры диффузии. Это возможно даже в том случае, если самоускоряющийся
процесс развития дефектов приведет к взрывному сценарию образования
критического дефекта.
Литература:
1. http://www.tech-e.ru/2007_4_60.php
2. http://www.stanford.edu/class/ee311/NOTES/Interconnect_Al.pdf