Технические науки / 6. Электротехника и
радиоэлектроника
д.т.н.
Невлюдов И. Ш., Жарикова И. В.
Харьковский
национальный университет радиоэлектроники
Анализ особенностей
создания электронных компонентов по BGA-технологии
В настоящее время постоянно ведется поиск новых
направлений техники корпусирования, новых корпусов компонентов.
Разработка новых корпусов компонентов для
поверхностного монтажа стала столь же важной задачей, как и разработка самих
компонентов. Особенно это касается современных интегральных схем, являющихся
основой современной радиоэлектронной аппаратуры и, прежде всего, вычислительной
техники.
Одним из наиболее перспективных направлений
техники корпусирования, призванных решить задачу конструкторско-технологической
реализации прогнозируемых интегральных схем, являются матричные корпуса BGA
(Ball Grid Array
– матрица шариковых выводов) и CSP (Chip Scale Package
– корпуса с размерами чипа). Такие корпуса с
большим количеством шариковых выводов под корпусом в последние годы получили
широкое применение благодаря высокому быстродействию и малым паразитным
параметрам, простоте монтажа, а также благодаря тому, что на плате они занимают
очень мало места [1]. Так, например, при максимальном количестве входов/выходов
(>5000) дополнительная площадь подложки, необходимая при монтаже, составляет
всего 8% (по сравнению с 39% для проволочных соединений при количестве выводов
300-500 и с 89% для кристаллов на ленточном носителе «лицевой стороной вверх»,
при количестве выводов 500-700).
Внешний вид корпуса BGA с матрицей шариковых
выводов представлен на рис. 1, а на рис. 2 приведены фотоизображения широко
распространенных сегодня интегральных схем в корпусах такого типа.
Кристалл Пластиковая
инкапсуляция Эпоксидная
подложка Капли
припоя

Рис. 1. Общий вид корпуса bga







Рис. 2. Стандартные ИС в выводами BGA
Микросхемы в корпусе BGA относительно недороги.
Согласно технологии сборки бескорпусные кристаллы интегральных схем монтируют
на поверхность печатной микроплаты, на которой с нижней стороны выполняется
массив (матрица) шариков припоя. Соединение контактных площадок кристалла
интегральной схемы и печатной микроплаты осуществляется с помощью золотых
проводников, а изоляция от влияния внешней среды – заливкой эпоксидным
компаундом [2].
Корпуса CSP являются развитием структур BGA и
могут включать в свой состав кристаллы с матричными выводами BGA или несколько кристаллов в одном
корпусе, а также внешние выводы корпуса в виде BGA. Использование CSP структур
позволяет уменьшить размеры интегральных схем почти на порядок. Корпуса CSP
обеспечивают существенное уменьшение площади, занимаемой корпусом на многослойной
коммутационной плате [3].
К достоинству контактных узлов с шариковыми
выводами следует отнести возможность автоматизации процесса группового монтажа,
а также обеспечение высокой плотности монтажа на подложке за счет минимальной
протяженности промежуточного звена.
Метод перевернутого кристалла («flip
chip») обеспечивает наилучшие электрофизические параметры, в том
числе быстродействие за счет минимальной длины соединений (табл.1).
Табл. 1. Параметры
распространения сигнала при монтаже перевернутым кристаллом
|
Индуктивность,
нГн |
5,6…0,3 |
|
Емкость,
пФ |
9,1…2,5 |
|
Сопротивление,
мОм |
20,1…1,7 |
|
Время
задержки, пс |
508…51 |
Сравнительные характеристики различных вариантов
монтажа приведены на рис. 3 [3].
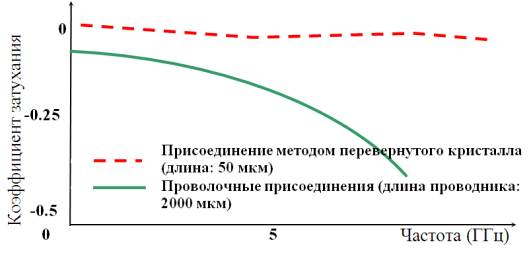
Рис. 3. Влияние способа монтажа на
частотные характеристики,
возможность использования схем на СВЧ
Конструкция с матричными
выводами обуславливает также ряд таких существенных преимуществ, как:
отсутствие выводов, подверженных изгибу;
эффект самоцентрирования в процессе оплавления; малые габариты; размер
многих микроBGA-компонентов приближается к размеру кристалла; малая
индуктивность выводов; большое количество и плотность выводов; низкопрофильность для многих типов
компонентов BGA; меньшее термическое
сопротивление между корпусом и печатной платой по сравнению с выводными
корпусами; возможность многочипового исполнения [4].
Перечисленные выше преимущества определяют
использование BGA-корпусов в таких областях, как: микропроцессоры и микроконтроллеры;
чипсеты ПК; широкий спектр мобильных устройств; заказные интегральные
микросхемы; микросхемы памяти.
Вместе с тем, компоненты с шариковыми выводами
имеют существенные недостатки, среди которых: необходимость высокой точности
совмещения полупроводникового кристалла с подложкой; возможность короткого
замыкания по металлизации полупроводникового кристалла (это особо угрожающая
ситуация для БИС с высокой плотностью размещения активных элементов);
невозможность монтажа полупроводникового кристалла в стандартном корпусе или
непосредственно на печатную плату, так как шариковые выводы требуют для
контактирования специальной коммутационной платы со строго определенным
расположением контактных площадок и высоким качеством поверхности; ограниченная
ремонтопригодность; дорогое обслуживание.
Можно также отметить в качестве недостатка для
BGA-компонентов такой фактор, как уменьшенный теплоотвод вследствие воздушного
зазора между полупроводниковым кристаллом и подложкой (по сравнению с
безвыводными корпусами, поверхность которых полностью соприкасается с
поверхностью печатной платы).
Однако по отношению к микросхемам со штырьковыми
выводами технология BGA имеет лучший тепловой контакт между
микросхемой и платой, что в большинстве случаев избавляет от установки
теплоотводов, поскольку тепло уходит от кристалла на плату более эффективно.
Если же рассеивание не достаточно, то на корпус
микросхемы устанавливают радиаторы, а пространство между ними заполняется
компаундом.
Также к недостаткам BGA-корпусов можно отнести
негибкие выводы с точки зрения недостаточной согласованности ТКЛР соединяемых
материалов и устойчивости контактных соединений к циклическим изменениям
температуры.
Так как выводы выполнены в виде шариков припоя
маленького диаметра (0,05-0,07 мм), их нельзя считать гибкими. Часто, при
тепловом расширении, сильной вибрации (ударах) некоторые выводы могут быть
повреждены. Поэтому BGA не является популярной технологией в
военной технике и авиастроении.
В некоторых модификациях корпуса герметизация
кристалла интегральной среды осуществляется металлической крышкой, которая
дополнительно выполняет функции теплоотвода.
Таким образом, при использовании BGA-технологии
необходимо внимательно анализировать особенности условий применения компонентов
и узлов на ее основе, например, с точки зрения таких параметров, как теплоотвод
и прочность BGA-выводов.
Литература:
1.
Грачов, А. О. Поверхневий монтаж при конструюванні й
виробництві електронної апаратури: рос. мовою. / А. О. Грачов, А. А. Мельник,
Л. І. Панов. - Одеса: ЦНТЕПІ ОНЮА, 2003. - 428 с.
2.
Кундас, С.П. Технология поверхностного монтажа: уч.
пособие / С. П. Кундас, А. П.
Достанко, Л. П. Ануфриев и др. - Минск: «Армито-Маркетинг, Менеджмент», 2000. -
350 с.
3.
Семенец,
В. В.
Технология межсоединений электронной аппаратуры: учеб. для вузов / В. В. Семенец, Джон Кратц,
И. Ш.
Невлюдов, В. А. Палагин. - Х. :
изд. «СМИТ», 2005. - 432 с.
4.
Ошибка!
Недопустимый объект гиперссылки.. - 04.08.2005.