Модели усталостных
разрушений паяных соединений
Медведев
А.М.
Проф.
МАИ, Президент Гильдии профессиональных технологов приборостроения
Павлов
Н.И.
Аспирант
МАИ
В последние годы были заново востребованы
и развиты модели усталостных разрушений применительно к оценке надежности
бессвинцовых паяных соединений. В Европе были развернуты широкие
экспериментальные исследования, чтобы предсказать последствия перехода на
бессвинцовые технологии паек. Главным источником информации для оценки
надежности явилась устойчивость паек к воздействию термоциклов, провоцирующих
термомеханические усталостные разрушения. Несмотря на хорошую повторяемость
этих экспериментов, признавать за ними окончательный вердикт никто не решается.
Потребовалось наполнение известных и хорошо отработанных моделей разрушения
новыми реологическими характеристиками новых припоев, чтобы использовать их для
предсказания надежности бессвинцовых паек в широком диапазоне их применения. Тем
не менее, точность инструментов предсказания надежности должна быть заново
проверена практикой эксплуатации аппаратуры, так как высокие температуры паек
сказываются на всех элементов межсоединений, а не только на пайках. Мы
ограничимся рассмотрением свойств двух популярных припоев (Sn59Pb40Ag1 и Sn95,5Ag3,8Cu0,7) и типичными
проблемами пайки компонентов (PBGA, CSP, Flip Chip на плате с подливом (underfill) и без него. Оценка надежности производилась на
основе устойчивости соединений к циклическому изменению температур.
Под действием нагрузок
установившиеся деформации припоев устанавливаются не сразу, а с некоторым
запаздыванием. При быстром приложении нагрузок сначала возникают упругие
деформации, которые со
Рисунок 1
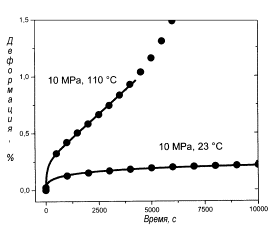 временем и с увеличением нагрузок перерастают в
пластические. Поскольку реологические свойства припоев существенно меняются от
температуры, релаксации деформаций при приложении нагрузки также имеют
температурную зависимость [1] (рисунок 1 - Ползучесть сплава Sn95,5Ag3,8Cu0,7
при температурах 23ºС и 110ºС под нагрузкой 10 МПа)
временем и с увеличением нагрузок перерастают в
пластические. Поскольку реологические свойства припоев существенно меняются от
температуры, релаксации деформаций при приложении нагрузки также имеют
температурную зависимость [1] (рисунок 1 - Ползучесть сплава Sn95,5Ag3,8Cu0,7
при температурах 23ºС и 110ºС под нагрузкой 10 МПа)
Значения температурной зависимости модуля
Юнга (E), коэффициента температурного расширения (КТР) и коэффициента Пуассона
(ν) материалов, участвующих в образовании паяных соединений, необходимы
для использования в моделях разрушения, на основе которых строятся прогнозы
поведения структур межсоединений. Значения этих характеристик, обеспечивающих
приемлемую прочность соединений, показаны в таблице 1 [1].
Таблица 1. Реологические
свойства бессвинцовых и эвтектических припоев
|
Тип припоя |
Модуль
Юнга, МПа |
Коэффициент
Пуассона |
КТР, К-1 |
|
Sn-Pb-Ag |
36000
при минус 60ºС; 21000 при 25 ºС |
0,36 |
24·10-6 |
|
Sn-Ag-Cu |
48500
при минус 60ºС; 33000 при 210 ºС |
0,36 |
20·10-6 |
Из приведенных в таблице 1 данных обращает
на себя внимание несколько меньшее значение КТР бессвинцового припоя
относительно эвтектического. С другой стороны, модуль Юнга сплава SnAgCu,
кажется, существенно выше, чем у эвтектики SnPbAg. Другой реологический
параметр, участвующий в анализе упругой деформации – коэффициент Пуассона
оказался одинаковым для обеих систем сплавов.
Для количественного сравнения
долговременной устойчивости бессвинцовых и свинец содержащих паяных соединений
была использована модель малоцикловых усталостных разрушений Коффина-Мэнсона
[2]. По этой модели исходя из амплитуд пластических деформаций ![]() под действием напряжений в направлении разрушений оценивается
среднее количество циклов Nf
до разрушения:
под действием напряжений в направлении разрушений оценивается
среднее количество циклов Nf
до разрушения:![]() , (1)
, (1)
где![]() - максимальная пластическая деформация в направлении
приложения усилий.
- максимальная пластическая деформация в направлении
приложения усилий.
Наравне с этим критерием устойчивости паянных
соединений к циклическим нагрузкам может использоваться энергия ползучести при
деформации в направлении разрушения: ![]() , (2)
, (2)
где ![]() - максимальная энергия пластической деформации, приходящаяся
на цикл нагрузки.
- максимальная энергия пластической деформации, приходящаяся
на цикл нагрузки.
Чтобы проверить достоверность этих моделей
в широком диапазоне устойчивости проанализированы найденные в открытых
источниках результаты термоциклических испытаний трех разновидностей
конструкций паяных узлов при различных режимах воздействий.
Flip Chip на стеклоэпоксидной подложке
без подлива – для анализа
малоцикловой усталости, конструкций с ограниченными усталостными ресурсами (несколько
сотен циклов), были использованы результаты испытаний модуля с флип-чипом на плате без заливки пазухи
компаундом [3]. Флип-чип на керамической основе имел два периферийных ряда
шариковых с шагом 0,45 мм. Кристалл имел размер - 6,7´6,7 мм. Под основаниями шариковых выводов химически
осаждался никель NiP. Кристалл был смонтирован на монтажной подложке из
материала FR-4 c паяльной маской. Покрытие монтажной
подложки под пайку – никель-золото по меди.
Испытания
проводились на устойчивость к термоциклам воздух-воздух
трех видов, °С: -50/+20, 0/+70 и +50/+120. Частота смены циклов 30 мин
на цикл с фиксацией на предельных температурах по10 мин и сменой температур – 5
мин.
Flip Chip на стеклоэпоксидной подложке с подливом – увеличение усталостной прочности (до 1000 и более
циклов) было достигнуто за счет заполнения пространства между кристаллом и
монтажной подложкой твердеющим компаундом [4]. Наложения двух механизмов отказов: тепловое расширение компаунда и
усталостные разрушения паек – обусловили сложность в анализе результатов
испытаний. Тем не менее, по данным металлографического анализа, приведенным в
работе [1], доминирующей причиной отказа явились усталостные разрушения паек. Хотя
и тепловое расширение заливочного компаунда создает дополнительное нагружение
паяных соединений, что несколько искажает чистоту эксперимента. Объектом
испытаний явились соединения кристаллов размером 10´10 мм2, смонтированных на подложке толщиной
1 мм из материала FR-4 с высокой температурой
стеклования (Tg) с покрытием под пайку никель-золото по меди. В качестве материала для
подлива был выбран компаунд Hysol
FP 4511.
Испытания
проводились на устойчивость к термоциклам воздух-воздух
двух видов, °С: -55/+125 и -55/+150. Частота смены циклов 30 мин на цикл
с фиксацией на предельных температурах по10 мин.
Пластиковые корпуса BGA-компоненты в пластиковых корпусах (PBGA 256 и 272) – для оценки устойчивости к 5000…10000 термоциклам
были испытаны на надежность PBGA-компоненты с 256 и 272 шариковыми выводами (четыре периферийных
ряда) с шагом сетки 1,27 мм [5]. Использовался кристалл 10´10 мм на ВТ-подложке [6]. PBGA монтировался на
монтажную подложку толщиной 1,57 мм из материала FR-4 c высокой
температурой стеклования. Испытания были проведены в режимах воздух-воздух
°С: -40/+125 и -40/+150.
Незначительный опыт использования
бессвинцовых технологий говорит о том, что надежность паяных соединений хотя и
зависит от выбора припоя, но в большей мере она связана с конструкцией паянного
узла. Но в конструкциях, где используются материалы с большой разницей
теплового расширения и при отсутствии компенсирующих элементов (например, LCCC-компонент на FR-4) надежность бессвинцовых паек явно хуже
традиционных [7].
Кроме
того, сравнение условий пайки говорит не в пользу бессвинцовых технологий.
Например, компонент CBGA-625 с пайкой припоем SnAgCu испытывает не только
увеличенную пиковую температуру, но и
увеличенный временной высокотемпературный интервал по сравнению с более мягкими
условиями пайки эвтектическими сплавами [8].
Надежность оценивалась количеством
термоциклов воздух-воздух
до единичных разрушений. По результатам испытаний строилось распределение
Вейбула. Принимались во внимание два
параметра этого распределения - β,
который является наклоном кривой распределения и θ, которая характеризует устойчивость к усталостным циклами
при накоплении 63,2% разрушений или средним количеством циклов до отказа
(приблизительно 50% накопленных разрушений).
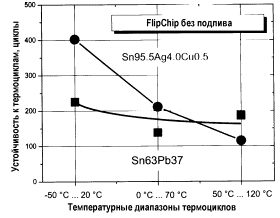 Результаты
испытаний конструкций Flip Chip без подлива демонстрируют большую устойчивость соединений
(примерно в 1,8 раза), выполненных бессвинцовыми сплавами SnAgCu в температурном
диапазоне минус 50/+20ºС и меньшую устойчивость (примерно на 2/3) в
диапазоне плюс 50/плюс120ºС.
Результаты
испытаний конструкций Flip Chip без подлива демонстрируют большую устойчивость соединений
(примерно в 1,8 раза), выполненных бессвинцовыми сплавами SnAgCu в температурном
диапазоне минус 50/+20ºС и меньшую устойчивость (примерно на 2/3) в
диапазоне плюс 50/плюс120ºС.
Рисунок 2
Для большей убедительности получены результаты испытаний с
тем же размахом термоциклов 0/70ºС, чтобы увидеть зависимость устойчивости
к термоциклам в различных температурных диапазонах (рисунок 2 - Сравнительные
характеристики устойчивости паяных соединений Flip Chip без подлива в различных температурных диапазона).
Результаты
испытаний паяных соединений PBGA-компонентов на стеклоэпоксидной
подложке с высокой температурой стеклования сведены в таблице 2.
Таблица 2. Устойчивость к термоциклам
паяных соединений PBGA-компонентов
с стеклоэпоксидной подложкой.
|
PBGA-тип Условия испытаний |
Характеристики устойчивости к термоциклам, циклы |
|
|
Sn-Ag-Cu |
SnPb |
|
|
PBGA-256 (27´27 мм2)-40°C/125°C, 60 мин [7] |
8083 |
3798 |
|
PBGA-272
(27´27 мм2)-40°C/125°C, 60 мин [8] |
Нет
данных |
5560 |
|
PBGA-272
(27´27 мм2) -40 °C /150°C, 44 мин [1] |
Нет
данных |
2814 |
|
PBGA-316
(35´35 мм2) -40 °C /125°C, 60 мин [3] |
3664-4187 |
2603 |
|
PBGA-313,
(27´27mm2)-40°C /125°C, 60 мин [4] |
4465-4917 |
2826 |
График на рисунке 3 показывает корреляцию
усталостных разрушений от различных ускоренных испытаний на различных конструкциях паяных узлов с использованием
припоев SnPb(Аg) и SnAgCu. Если уравнение (1)
справедливо, график зависимости усталостной ползучести от циклических нагрузок должен
быть прямой линией. Как видно из рисунка, это положение приблизительно верно. Таким
образом модели предсказания устойчивости паяных соединений для припоев SnPb(Аg) и SnAgCu строятся на прямых, проходящих через
экспериментально найденные точки из 14 экспериментов. Результаты исследований
демонстрируют, что разрушения, накапливаемые при воздействии термоциклов, коррелируют с накапливаемыми деформациями ползучести примерно одинаково для обеих
типов припоев.
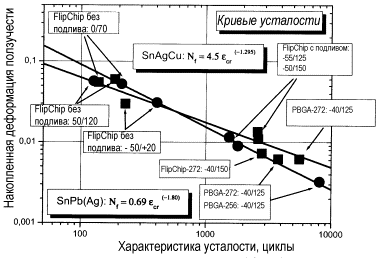
Рисунок 3
Опубликованные экспериментальные данные
позволяют подтвердить достоверность моделей разрушения паяных соединений и на
их основе – прогнозировать надежность паянных узлов, выполненных по
бессвинцовой и традиционной технологиям.
Все приведенные здесь результаты испытаний
получены в воздушной среде (воздух-воздух),
чем обусловлена некоторая мягкость смены температур при термоциклировании.
Возможно, изменение условий испытаний на термоциклирование жидкость-жидкость даст более достоверные испытания. Очевидно, еще
более достоверные результаты можно получить только в реальных условиях
долговременной эксплуатации. Тем более что температурные воздействия при пайках
сказываются и на других элементах межсоединений: металлизации отверстий,
внутренних соединениях в МПП, адгезии фольги к подложке и т.д.
Объединение экспериментальных и теоретических
исследований паяных соединений позволяют утверждать, что для нагруженных паек
усталостные разрушения при использовании бессвинцовых припоев типа SnAgCu
наступают несколько позже, тогда как в области относительно меньших (реальных) напряжений
эвтектический припой SnPb(Аg) ведет себя
лучше.
Литература
1. A. Schubert, R.
Dudek, E. Auerswald, A. Gollhardt, B. Michel, H. Reichl (Fraunhofer IZM, Micro
Materials Center Berlin). Fatigue Life Models for SnAgCu and SnPb Solder Joints
Evaluated by Experiments and Simulation./Proceeding of 53th Electronics
Components and Technology Conf. ECTC 2003, New Orleans, USA, 27-30 May 2003.
pp. 458-468.
2.
А. Медведев. Технологическое
обеспечение надежности электронной аппаратуры./ Производство электроники:
Технологии, Оборудование, Материалы, №8, 2006.
3. A. Schubert, R. Dudek, R. Leutenbauer, R. Doring, J. Kloeser, H. Oppermann, B. Michel, H. Reichl, D. Baldwin, J. Qu, S. Sitaraman, M. Swaminathan, C.P. Wong, R. Tummala. Do Chip Size Limits
Exist for DCA? / IEEE Transactions on Electronics Packading Manufacturing, Vol.
22, No. 4, Oct. 1999.
4. R. Dudek, R. Doring, B.
Michel. Reliability
Prediction of Area Array Solder Joints/ Procceding International Conference
EuroSimE/ Paris, France, April 2001.
5. A. Schubert, R. Dudek, R.
Doring, H. Walter, E. Gollhardt, B. Schuch, H. Sitzman, B. Michel. Lead-Free Solder Intercjnnects: Characterization,
Testing and Reliability./ Proceeding 3th Inter. Conf. on Benefiting from
Thermal and Mechanical Simulation in (Micro)-Electronics. Paris, France, April
2002
6.
А. Медведев. Печатные
платы. Конструкции и материалы./М.: Техносфера. 2005.
7. A. Syed.
Reliability and Au Embritelement of Lead Free Solders for BGA Applications//
Proc.Intern. Symposium and Exhibition on Advanced Packading Materials,
Braselton, Georgia, USA, March, 2004.
8. A. Syed.
Reliability of Lead Free Solders Connections for Area-Array Packages. Proc. IPC
SMEMA Council, APEX, LF2-7, January, 2007.
9.
Матиас Новоттник, А.
Новиков. Надежность бессвинцовых электронных узлов./ Технологии в электронной
промышленности, №1, 2007.