Левченко В. В., Соколов М. Е.
Кубанский Государственный Университет,
Россия
РАЗРАБОТКА СИСТЕМЫ СТАНДАРТНЫХ
ОБРАЗЦОВ ДЛЯ
ОПРЕДЕЛЕНИЯ СОСТАВА ОДНОСЛОЙНЫХ
ТОНКОПЛЕНОЧНЫХ
СИСТЕМ НА ОСНОВЕ МЕТАЛЛОВ И ИХ
СПЛАВОВ МЕТОДОМ
ЭНЕРГОДИСПЕРСИОННОЙ
РЕНТГЕНОВСКОЙ СПЕКТРОСКОПИИ
Страны, вступившие в нанотехнологический прорыв, хорошо представляют необходимость опережающего развития метрологии в этой бурно развивающейся области. Именно уровень точности и достоверности измерений способен стимулировать развитие соответствующих отраслей экономики либо сдерживать его. Особо важно то, что в нанотехнологиях приборноаналитическая и технологическая составляющие работают на пределе возможностей. В этой связи метрологии и стандартизации принадлежит особая роль ключевых элементов приборно-аналитической, технологической и интеллектуальной составляющих нанотехнологий и наноиндустрии. Специфика нанотехнологий привела к необходимости зарождения и быстрого развития уникального направления в метрологии – нанометрологии, с которым связаны теоретические и практические аспекты «правильности» измерений, включая эталоны единиц величин; стандартные образцы состава, структуры, размера, свойств; методы и средства калибровки в нанометровом и субнанометровом диапазонах; реализацию наношкалы и многие другие аспекты обеспечения единства измерений.
Фундаментальные исследования в нанотехнологиях дают метрологии новые знания и принципы построения эталонов, создания стандартных образцов, требуют новых методов и средств обеспечения единства измерений. Проблемно-ориентированные исследования в нанотехнологиях открывают новые возможности и новые потребности измерительного базиса. Так, изучение особенностей взаимодействия измерительных нанозондов, пучков заряженных частиц, рентгеновского и оптического излучений с наноструктурированными объектами определили цели, задачи и пути решения проблем нанометрологии и стандартизации, метрологического обеспечения измерений в нанотехнологиях, разработки стандартизованных методик измерений и калибровки стандартных образцов и мер состава, структуры, размера и свойств и средств измерений, а также стандартизованных методик измерений требуемых параметров объектов и продукции наноиндустрии.
В связи с быстрым развитием нанометрологии данная тема выпускной квалификационной работы приобретает высокую актуальность, так как нанотехнологии успешно развиваются по всему миру и стандартные образцы для поверки и калибровки приборов, вводимые в систему стандартов, не успевают разрабатываться.
В работе исследуются:
- тонкопленочные образцы сплава Хромель (Cr/Ni) на кремниевой подложке с толщиной от 20, 40, 60, 80, 100, 120, 140, 160 нм методом магнетронного распыления;
- Провести энергодисперсионный рентгеновский микроанализ полученных образцов.
Процесс изготовления образцов представлял собой напыление слоев Cr/Ni в диапазоне от 20 до 160 нм.
В качестве подложки для напыления металла использовались кремнёвые пластины 2 - 5 мм в ширину, 5 – 10 мм в длину и толщиной 30 - 50 микрон. Было изготовлено восемь кремниевых пластин. Следующим этапом идет подготовка образцов к напылению. Подготовка подложек заключалась в химические очистки («жидкостная очистка»), которая проходит в несколько стадий с применение концентрированных химических реагентов.
Процесс химической очистки:
- H2SO4/H2O2 (7:3) при 120 °C – удаляются органические загрязнения, ионы металлов;
- H2O/HF (100:0,5) 20 °C – удаляется пленка естественного слоя SiO2;
- NH4OH/H2O2/H2O (1:1:6) при 80 °С – удаляются механические частицы, органические загрязнения;
- HCl/H2O2/H2O (1:1:6) при 80 °С – удаляются металлические загрязнения;
- отмывка в воде после обработки в каждом из реагентов; - сушка.
В рамках проведения эксперимента был осуществлен анализ мишени Cr/Ni на растравом электронном микроскопе с применение ЭДС. Показания спектров снимались при ускоряющем напряжении в 10 кВ и спектры брались по всей площади и по пяти точкам на ней, как изображено на примере рисунка 4.
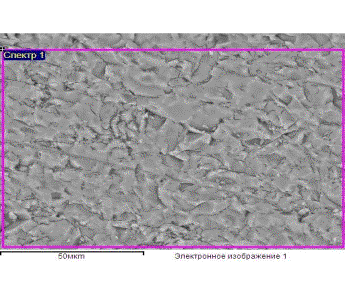

Рисунок 4 – Спектр всей площади исследуемой области образца при ускоряющем напряжении 10кВ
Нам нужно было выяснить какое содержание химических элементов содержится в мишени, используемой для напыления тонкопленочных систем на кремниевой основе. Полученные данные указаны в таблице 1.
Таблица 1 - Процентное содержания Cr, Ni в мишени Cr/Ni ускоряющем напряжении 10 кЭв
|
Наименование спектра |
Cr (%) |
Ni (%) |
|
Спектр1(по всей площади) |
35,81 |
64,19 |
|
Спектр 2 (по точкам) |
25,47 |
74,53 |
|
Спектр 3 (по точкам) |
100 |
0 |
|
Спектр 4 (по точкам) |
85,71 |
14,29 |
|
Спектр 5 (по точкам) |
24,21 |
57,79 |
|
Спектр 6 (по точкам) |
100 |
0 |
|
Среднее значение спектров |
71,23 |
29,32 |
Из таблицы, представленной выше мы видим, как изменяется процентное содержание Cr и Ni в разных спектрах, взятых по точкам. Это объясняется тем, что сплав хромель использовавшийся для напыления тонкопленочных систем является не однородным. Так же на рисунке 5 изображена гистограмма изменения концентрации характеристических рентгеновских пиков в зависимости от разных спектров.

Рисунок 5 – Изменение концентрации элементного состава на всей области образца
Далее проводились исследования каждого образца напыленного слоя на растровом электронном микроскопе методом энергодисперсионного рентгеновского анализа. На каждом образце были взяты по шесть спектров, один из которых общий по всей площади исследования. Показания снимались при ускоряющем напряжении в 10, 15, 20 кВ, что привело к большому числу данных. После обработки полученных результатов была составлена таблица среднего значения концентрации химических элементов (со все площади спектра) в зависимости от ускоряющего напряжения и толщены напыляемого слоя. Данные представлены в таблице 2.
Таблица 2 - Среднее значение концентрации элементов
|
Толщина слоя |
|
|
Ускоряющее напряжение кВ |
|
|
||||
|
|
10 |
|
15 |
|
20 |
|
|||
|
Si |
Cr |
Ni |
Si |
Cr |
Ni |
Si |
Cr |
Ni |
|
|
Исходная мишень |
- |
71,23 |
29,32 |
- |
- |
- |
- |
- |
- |
|
20 нм |
87,52 |
3,59 |
8,88 |
98,12 |
1,62 |
0,22 |
98,75 |
0,23 |
1,15 |
|
40 нм |
61,93 |
15,33 |
22,54 |
89,35 |
9,67 |
0,97 |
79,37 |
4,47 |
0,42 |
|
60 нм |
58,40 |
16,3 |
25,56 |
88,97 |
10,16 |
0,87 |
93,55 |
0,68 |
5,78 |
|
80 нм |
71,02 |
13,33 |
15,44 |
93,30 |
6,11 |
0,59 |
96,14 |
3,29 |
0,35 |
|
100 нм |
44,04 |
27,07 |
28,89 |
96,45 |
12,23 |
1,14 |
93,25 |
6,10 |
0,64 |
|
120 нм |
47,12 |
25,36 |
27,51 |
78,88 |
19,27 |
1,87 |
90,68 |
0,91 |
8,40 |
|
140 нм |
28,38 |
30,66 |
40,83 |
72,02 |
25,54 |
2,93 |
83,84 |
14,58 |
1,55 |
|
160 нм |
37,28 |
29,10 |
33,61 |
73,93 |
23,71 |
2,32 |
88,79 |
10,15 |
1,04 |
По результатам, приведенным в таблице выше, были построены гистограммы изменения концентрации химических элементов в тонкопленочной системе в зависимости от толщины и представленные при разном ускоряющем напряжении на рисунках 1,2,3.
90 80 70 60 50 40 30 20 10 0 20 НМ 40 НМ 60 НМ 80 НМ 100 НМ 120 НМ 140 НМ 160 НМ ТОЛЩИНА СЛОЯ
|
Рисунок 1 – Изменение концентрации элементного состава на толщине слоя от
20 до 160 нм при напряжении 10 кВ

Рисунок 2 – Изменение концентрации элементного состава на толщине слоя от
20 до 160 нм при напряжении 15 кВ

Рисунок 3 – Изменение концентрации элементного состава на толщине слоя от
20 до 160 нм при напряжении 20 кВ
Итак, по результатам гистограмм мы видим, что концентрация содержания кремния значительно увеличивается в зависимости от изменения ускоряющего напряжения. Т. е. это можно объяснить тем, что при увеличении ускоряющего напряжения электронного пучка, он проникает в глубь подложки, на которую производилось напыление. И соответственно выдает результат спектрального анализа, в котором содержание кремния значительно больше, чем химических элементов, нанесенных на поверхности. При 20 кВ в пленке 40 нм так же можем наблюдать резкое увеличение хрома. В связи с тем, что в работе использовались кремневые подложки не полированные, а прошедшие только химическую отчистку, то можно судить о неровности поверхности кремния, что и привело к такой картине распределения характеристического рентгеновского спектра.
Для составления и выведения стандартных образцов пленок хромеля были взяты данные из всех спектров в зависимости от толщины и ускоряющего напряжения электронного пучка. При 10 кВ на растровом электронном микроскопе были сделаны снимки в разных режимах просмотра (рисунок 4).


Рисунок 4 – Изображение пленки Cr/Ni 20 нм при 1000 увеличении
Итак, после анализа полученных данных, был разработан стандартный образец тонкопленочной системы на основе металла хромель на кремниевой подложки. Стандарт разрабатывался относительно толщины напыленного слоя, ускоряющего напряжения, при котором был получен анализ образца, и изменения характеристических пиков относительно результатов спектрального анализа мишени Cr/Ni.
При 10 кВ процентное содержание химических элементов составляет:
- 10 % - 15 % Si;
- 60 % - 70 % Cr;
- 40 % - 50 % Ni.
При 15 кВ соотношение химических элементов составляет:
- 35 % - 40 % Si;
- 55 % - 65 % Cr; - 10 % - 25 % Ni.
При 20 кВ:
- 50 – 65 % Si;
- 25 – 35 % Cr; - 15 – 20 % Ni.
Чем выше ускоряющее напряжение при просмотре на растровом электронном микроскопе, тем больше разброс данных получается при проведении спектрального рентгеновского анализа. Соответственно процентное содержание химического состава при анализе в 20 кВ зависит от выбранной области спектра образца.
Результат исследовательской работы состоит в следующем:
- Получена серия тонкопленочных систем на основе сплава хромель (Cr/Ni) на кремниевой подложки, с толщиной слоев: 10, 20, 40, 60, 80, 100, 120, 140, 160 нм;
- Изучено влияние толщины пленки на соотношение характеристических сигналов в рентгеновском спектре, в зависимости от ускоряющего напряжения зондового пучка;
- На основе полученных данных разработана система стандартных образцов однослойных тонкопленочных систем Cr/Ni на кремниевой подложки, в зависимости от ускоряющего напряжения электронного пучка и толщены напыленного слоя.
Так же сделан вывод, что при увеличении ускоряющего напряжения электронного пучка в растровом электронном микроскопе энергии достаточно что бы проникнуть вглубь подложки, что приводит к получению результатов спектрального анализа не однослойных тонких пленок, а содержание химических элементов в самой подложке. В связи с этим эффектом изучение тонкопленочных систем на предмет количественного анализа стоит проводить при ускоряющем напряжении не более чем 15 кВ.
