Уколов О.І.,* Лазебник С.А.,* Уколова Ю.В.**
*Горлівський автомобільно-дорожній інститут
**Горлівський машинобудівний коледж
Методика
визначення дифузійної довжини нерівноважних носіїв заряду у приповерхневих
шарах монокристалів Ge
У
технологіях виготовлення напівпровідникових приладів використовуються різні
методи модифікації приповерхневих шарів кристалів, що спрямовано змінюють їх
фізичні властивості: легування домішками, опромінювання частками високих
енергій, шліфування і механічне полірування [1]. Крім того, властивості
приповерхневих шарів Ge, Si і кристалів типу А3В5 можуть
істотно змінюватися за рахунок генерації структурних дефектів після
низькотемпературної деформації [2-4]. Зміну властивостей напівпровідника
внаслідок утворення дефектів структури (дислокацій, точкових дефектів і їх
агломерацій) оцінюють по зміні структурно - чутливих електричних параметрів -
дифузійній довжині пробігу,
нерівноважних носіїв заряду LD і їх часу життя τ [5]. Відомі
методики [5] визначення цих параметрів дозволяють визначити LD і
τ для об'єму кристалів. Тому
важливим завданням даної роботи було вивчити можливості визначення LD
і τ для тонких приповерхневих шарів кристалів і знайти критерії
застосовності методик оцінки цих параметрів для приповерхневих шарів і об'єму
роздільно.
У даній роботі виконані
дослідження можливості використання фотоелектричного методу для вимірювання
дифузійної довжини LD нерівноважних носіїв заряду в приповерхневих
шарах кристалів Ge, що мають структурні відмінності з об'ємом. Вимірювання виконані
за різних умов генерації нерівноважних носіїв заряду (рис.1): вузькою смугою
світла яке слабопоглинається (а), сфокусованою світловою точкою від нитки
розжарення (б) і від лазера з довжиною хвилі λ =640 нм (в). Теоретичний
аналіз глибини генерації нерівноважних носіїв заряду в зразку Ge показав, що
випромінювання вольфрамової нитки розжарення можна вважати як слабопоглинаюче і
яке проникає углиб зразка до 5 мм, оскільки значна частина спектру
випромінювання знаходиться в інфрачервоному діапазоні. В результаті
використання зонда від лазерного джерела випромінювання з довжиною хвилі λ=640
нм глибина генерації нерівноважних носіїв заряду складала 0,5 мкм.
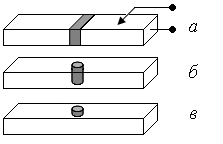
Рис.1. Геометрія області
генерації нерівноважних носіїв заряду в напівпровідниковому зразку Ge
При експериментальному визначенні довжини дифузії LD у кристалах
p-Ge для прикладів (б,в) використовували формулу [6]
![]() (1)
(1)
а для прикладу (а) формулу
![]() (2)
(2)
За отриманими даними
побудовані графіки залежностей логарифма напруги в колекторному ланцюзі lgU від координати x (рис.2). Для визначення зміни
концентрації неосновних носіїв ∆n~lgU, пов'язаною з рекомбінацією в приповерхневому шарі, вимірювання проводили
в інтервалі 0<x< LD. На рис. 2 спостерігаються незначні
розходження результатів вимірювань і розрахункових значень LD,
вказаних в таблиці за різних умов генерації нерівноважних носіїв заряду.
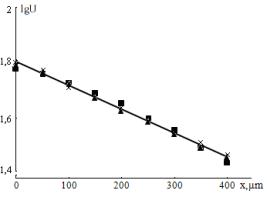
Рис.2. Графік залежності lgu(x)
при різній геометрії області генерації нерівноважних носіїв заряду: ■ -
освітлення тонкою смугою світла з плоскою областю генерації нерівноважних
носіїв заряду × - освітлення
малою світловою точкою з циліндричною
областю генерації по всій товщині зразка, ▲- освітлення малою світловою
точкою з циліндричною областю генерації на глибині до 0,5 мкм
|
Фотоелектричний метод LD,мм |
Метод модуляції провідності LD,мм |
||
|
0,491(а) |
0,489(б) |
0,507(в) |
0,505 |
Вони близькі також до значення LD, знайденого методом модуляції
провідності в точковому контакті з поверхнею напівпровідника при малих часах
затримках вимірювального імпульсу [7] по формулі![]() , де D -
коефіцієнт дифузії нерівноважних носіїв заряду.
, де D -
коефіцієнт дифузії нерівноважних носіїв заряду.
Таким чином, в роботі
показана можливість використання фотоелектричного метода для вимірювання
параметрів рекомбінації нерівноважних носіїв заряду у тонких приповерхневих
шарах с підвищеною концентрацією структурних дефектів. Перехід до точкового
освітлення зразка дозволяє отримати таку інформацію на малих по площі
структурах.
Література:
1. Готра З.Ю./ Технология микроэлектронных
устройств. – М.:Радио и связь. – 1991.
– 528с.
2. Надточий В.А., Нечволод Н.К.,
Сущенко Д.Г. Исследование электрических свойств Ge и Si, деформированных при низких температурах //Физ. и техн. высоких давлений.
– 2001. – Т.11, №1. – С.104 – 110.
3. Nadtochiy V., Golodenko N.,
Nechvolod N. Recombination of non-equilibrium charge carriers injected into Ge through intermediate defective
layers // Functional Materials. – 2005. – V.12, №1. – P.45 – 50.
4. Надточий В.А., Нечволод Н.К.,
Голоденко Н.Н. Микропластичность и электрические свойства Ge и Si, деформированных при низких температурах // Вісник Харківського
університету, серія “Фізика”. – 2003. – №600, вип. 7. – С.101 – 104.
5. Батавин В.В. и др. Измерения
параметров полупроводниковых материалов и структур. – М.:Радио и связь. – 1985.
– 264 с.
6. Уколов А.И., Надточий В.А., Уколова Ю.В. Измерение параметров рекомбинации
неравновесных носителей заряда в приповерхностных слоях монокристалла германия // Материалы международной конференции по физике полупроводников «Лашкаревские чтения –2011». – Киев.
7. V. Nadtochiy, N. Golodenko,
N. Nechvolod. Microplasticity and electrical properties of subsurface
layers of diamond – like semiconductors strained at low temperatures// Functional
Materials. –2003.–V.10,№4 – P.702-706.