Математика/5. Математическое
моделирование
Верюжский
И.В., Бухлин А.В., Павлов Д.А.
Национальный
исследовательский университет «МИЭТ»
Моделирование процесса магнетронного напыления многокомпонентных
высокотемпературных сверхпроводников
Создание электронных
приборов на основе высокотемператруных сверхпроводников в значительной мере
связано с решением технологических трудностей формирования тонких слоев
многокомпонентной системы. При использовании магнетронного метода распыления
экспериментальный поиск технологических
режимов является весьма трудоемким и затратным процессом. Для решения задач оптимизации параметров
нанесения ВТСП эффективно математическое моделирование процессов
осаждения.
Существующие
модели процесса переноса распыленных атомов при магнетронном нанесении [1-4],
рассматривают вопросы переноса с точки зрения термализации частиц и диффузии
термализованного потока при повышенных давлениях газовой смеси. Однако данные
модели не дают строгого физического описания пространственного распределения
плотности, потока и скоростей частиц в межэлектродном пространстве.
Изменение
величины сечения упругого рассеяния и углов рассеяния в зависимости от скорости
относительного движения частиц затрудняет описание процесса переноса с позиции
классической теории рассеяния.
Существенным
недостатком многих, представленных в литературе моделей, является тот факт, что
они не позволяют оценить на подложке распределение
концентрации каждого сорта атомов в многокомпонентной системе.
Особенностью предлагаемой
модели является описание процессов распыления в переходной области между
отсутствием столкновений атомов металлов и их полной термализацией.
Необходимость использования переходных режимов связана с условиями формирования
слоев сверхпроводника состава Bi2Sr2Ca2Cu3O10 толщиной менее 100 нм. При низких давлениях газовой
смеси частицы с большой энергией
бомбардируют поверхность подложки, создают дефекты и нарушают стехиометрию
осажденного слоя. Использование давлений 20….100 Па также нарушает соотношение
между пятью компонентами сверхпроводника.
Разработанная модель
является имитационной, отслеживает поведение каждого испаренного атома. Модель
учитывает распределение энергии и угла разлета атомов мишени, скорость
испарения на различных участках мишени, вероятность длины свободного пробега,
температуру в различных точках активного пространства, условия изменения
траектории после соударения, условия прилипания к поверхности подложки,
особенности параметров всех компонентов сверхпроводника (BiPb)2Sr2Ca2Cu3O10.
Выбор конструкции
магнетронного распылительного источника осуществлялся на основе проведенных
расчетов моделирования магнитной системы с учетом реальных магнитных и
электрических полей. Оптимальной конструкцией для нанесения ВТСП пленок оказалась
цилиндрическая. Магнитная система включает в себя центральный магнит и
магнитопровод. Для увеличения площади покрытия
подложки распыляемым материалом в магнитную систему дополнительно вводился
полюсный наконечник. Моделирование проводилось с помощью программного комплекса
построенного на методе конечных элементов, результат моделирования магнитной
системы реального источника с полюсным наконечником показан на рисунке 1.
Индукция магнитного поля у поверхности мишени составляет порядка 0,08 Тл.


Моделирование
процессов переноса распыленных атомов из мишени на подложку проводилось с
учетом выбранной конструкции магнетрона. Внутренний диаметр зоны эрозии
равнялся 40 мм, внешний диаметр 90 мм, используемая мишень имела диаметр 100
мм.
В случае
ионно-плазменного распыления мишени применим косинусоидальный закон распределения
для угла вылетевшего атома [4]. В нашем случае, это угол между направлением
вектора скорости атома и осью z.
Таким образом,
вылетевший из мишени атом будет иметь следующие параметры: модуль начальной
скорости i-го
атома j-го сорта - Vij, угол испарения
φi (угол между вектором скорости V и осью z), азимутальный угол G между осью Х Декартовой системы координат и направлением
проекции вектора V в
плоскости XY.
Длина
свободного пробега λqhs
испаренных атомов в газовой среде будет
иметь вид:
 1.1
1.1
Где N – концентрация
атомных частиц в рассеивающей среде.
После
соударения модуль и направление вектора Vij (0)
изменятся и станут Vij (1).
В общем виде для вектора скорости атома после k-го столкновения можно записать Vij (k). Рассмотрим более подробно процесс перемещения атома
с учетом столкновений, возврата на мишень, осаждения на подложку и уход в
систему откачки газов. Для этого получим формулу, связывающую вектор скорости
до и после столкновения.
Определим угол рассеяния
при упругом соударении распыленного атома с атомом газа. Схема упругого столкновения показана на рисунке 2.
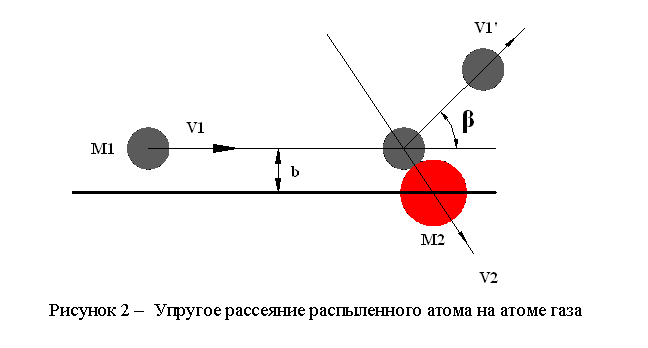

Угол
рассеяния после соударения распыленного атома с атомом газа можно определить из
законов сохранения энергии и импульса, выражение будет иметь вид [5]:
 1.2
1.2
Используя все
сказанное выше, напишем уравнения для трека каждого отдельного атома. X0 и Y0 начальные
координаты вылетевшего атома. При этом имеем ввиду, что в нашей системе Z0 =0.
Текущие
координаты до первого столкновения можно записать как:
X = Vx
t + X0 Y = Vy t +
Y0 Z = Vz t +
Z0 где t – время процесса
Соответственно
координаты в момент первого столкновения будут:
X1 = Vx t1 + X0
Y1 = Vy t1 + Y0
Z1 = Vz t1 + Z0 где t1 – время первого столкновения.
После первого
столкновения компоненты вектора скорости станут Vx1, Vy1, Vz1. Соответственно координаты
при i -ом столкновении будут.
Xi = Vx ti +
Xi-1 Yi = Vy ti +
Yi-1 Zi = Vz ti +
Zi-1
где ti – время i -го столкновения.
А текущие
координаты после i –
го столкновения:
X = Vxi t +
Xi Y = Vyi t +
Yi Z = Vzi t +
Zi
где ti-1 – время
процесса после i-го
столкновения.
Описанный
процесс будет происходить до тех пор, пока не будет выполнено одно из условий:
Атом окажется
на поверхности подложки: Z = Zп
Атом окажется
на поверхности мишени (возврат): Z = Zм
Атом ушел в
систему откачки газа: (X2+Y2) > Rм
В
этом случае процесс исследования трека атома прекращается и начинается имитация
движения следующего атома того же сорта. При попадании на подложку считается,
что атом остался на месте касания с
координатами X,Y. После набора статистики для nk атомов j – го сорта, начинается анализ треков атомов сорта j+1. Здесь n число, выбранное для получения
статистически значимой выборки. k – число атомов j –го сорта в формуле 2223.
Таким образом, мы получим координаты всех исследованных атомов, которые
достигли подложки. Соответственно и профиль распределения концентрации
компонентов сверхпроводника при испарении из малого источника с координатами X0 и Y0.
Результатом
моделирования является профиль
распределения толщины D нанесенной
пленки сверхпроводника (Bi,Pb)2Sr2Ca2Cu3O10 на подложке диаметром L с учетом соблюдения стехиометрии в зависимости от расстоянием
мишень-подложка H.
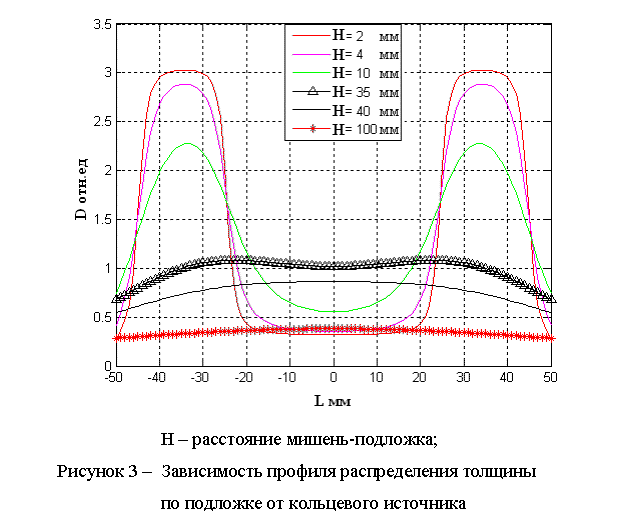

Результатом проведенной
работы является разработанная модель процесса осаждения распыленных атомов,
используемая для оптимизации конструкции
распылительного источника и технологических параметров осаждения методом
магнетронного нанесения ВТСП-пленок состава (Bi,Pb)2Sr2Ca2Cu3O10.
Литература
1. Valles-Abarca J.A.,
Gras-Marti A. Evolution towards thermalization, and diffusion, of sputtered
particle fluxes: Spatial profiles // J.Appl.Phys. – 1984 – Vol. 55 - №
5 – P.1370-1378
2.
Жиглинский А.Г.,
Кучинский В.В. Массоперенос при взаимодействии плазмы с поверхностью // Москва:
энергоатомиздат, 1991
3.
Каштанов П.В., Смирнов
Б.М., Хипплер Р. Магнетронная плазма и нанотехнология // УФН – Т.177 - № 5 –
2007 – С.473-510
4.
Технология тонких пленок
/ под ред. Майссел Л., Гленг Р. М.: Сов. радио, 1997
5.
Вольпяс В.А., Козырев
А.Б. Физика слабоионизированной плазмы // ТОО “Складень” Санкт-Петербург – 1997
– 130 С.