Технические науки /
6.Электротехника и радиоэлектроника.
д.т.н., проф. Осадчук В.С., д.т.н., проф. Осадчук О.В., Дуда Р.В.
Вінницький національний технічний університет
Огляд методів визначення часу життя
носіїв заряду в напівпровідниках
Час життя носіїв заряду в напівпровідниках є важливою
складовою, що визначає параметри матеріалу, які в свою чергу впливають на
характеристики напівпровідникових пристроїв, які використовують електронні
властивості носіїв заряду. Існує значна
кількість методів визначення часу життя, проте всі вони є не досить точними.
Тому необхідно проводити додаткові дослідження для підвищення точності виміру
цього параметру.
Аналіз методів визначення часу
життя носіїв заряду в напівпровідниках. Найбільш ефективними методами
вимірювання часу життя неосновних носіїв заряду являються наступні:
1.
Стаціонарні
методи: метод вимірювання дифузійної довжини, оснований на використанні
рухомого світового зонда, а також метод вимірювання фотоелектромагнітного
ефекту та стаціонарної провідності.
2.
Нестаціонарні
методи: імпульсний метод затухання фотопровідності, який використовується при
вимірюваннях на пластинах та на злитках, а також методи з використанням р- n переходів.
Знаючи
потрібний час життя можна обрати певну технологію виготовлення того чи іншого
виробу, наприклад, легування кремнію золотом приводить до зменшення часу життя
неосновних носіїв заряду, а при використанні гетеру час життя, навпаки,
збільшується. Важливо відмітити, що часто важливо вимірювати час життя в
готовому пристрої, а не в вихідному матеріалі.
Метод рухомого світлового променя [2,3,4]. Суть
методу полягає в наступному, плоска поверхня напівпровідника (спеціально
виготовлена вимірююча смужка чи торець злитка) освітлюється вузькою смужкою
світла в точці х=0. На деякій відстані
від смужки світла знаходиться колекторний контакт. Вимірюється фото ЕРС, яка
виникає між колекторним контактом та неосвітленою частиною зразка. Величина
фото ЕРС при малих сигналах ![]() пропорційна
концентрації неосновних носіїв заряду в області колектора.
пропорційна
концентрації неосновних носіїв заряду в області колектора.
Збиткові
носії заряду, які генеруються в області освітлення дифундують вздовж зразка.
Переміщуючи світловий потік по довжині зразка можна отримати залежність Uфото ЕРС=f(x), де x – відстань від краю світлової смужки до колекторного
контакту. Недоліком такого методу є те, що при освітленні тонкою смужкою світла
зразка, товщина якого менша довжини, вимірюване значення дифузійної довжини
значно занижується за рахунок впливу швидкості поверхневої рекомбінації.
Метод
рухомого світлового зонду має цілий ряд модифікацій, які в тій чи іншій мірі
використовуються в основному для дослідницьких цілей. Збудження носіїв може
відбуватись точковою світловою плямою, при цьому можна вважати, що збиткова
концентрація носіїв заряду є функцією r (сферична симетрія).
При точковому джерелі світла концентрація збиткових носіїв заряду струму мала,
тому для її збільшення можна використовувати освітлення в вигляді кола. При
досить великому радіусі кола ![]() . Даний спосіб вимірювання не отримав широкого розповсюдження, так як не
має великих переваг над способом описаним вище, а лише технічно складніший.
. Даний спосіб вимірювання не отримав широкого розповсюдження, так як не
має великих переваг над способом описаним вище, а лише технічно складніший.
Більш широкого застосування досягнув метод швидкого
рухомого світлового променя [1]. Суть методу полягає в тому, що на досліджуваний зразок падає пучок
світла, який рухається з постійною швидкістю по світлочутливій поверхні
кристала, на якій встановлений металевий зонд (колектор). В освітленій області
створюються збиткові носії струму, які дифундують в неосвітлену область з
швидкістю дифузії
![]() , (1)
, (1)
де L – середня дифузійна довжина; ![]() – час життя.
– час життя.
При рухомій світловій плямі функції
розподілу збиткових носіїв заряду по об’єму неосвітленого кристалу мають
вигляд:
 (2)
(2)
Функція p(x) визначається експериментально – вимірюване фото ЕРС, яке виникає під дією
світла на колекторі.
По постійних L1 та L2, які знаходяться з експериментально
отриманих кривих, може бути отриманий час життя за допомогою наступної функції [2]
![]() , (3)
, (3)
Зазвичай L1 та L2 знаходять по нахилу прямих ![]() . Оскільки х змінюється в часі з рухом світлової плями, то за горизонтальну вісь
можна прийняти вісь часу, при цьому розрахунок проводити виходячи з графіка
. Оскільки х змінюється в часі з рухом світлової плями, то за горизонтальну вісь
можна прийняти вісь часу, при цьому розрахунок проводити виходячи з графіка ![]() . При цьому співвідношення (3) набуває наступного
вигляду:
. При цьому співвідношення (3) набуває наступного
вигляду:
 . (4)
. (4)
Однією з модифікацій методу рухомого
зонду являється метод, коли до зразка в формі паралелепіпеда підключають три
контакти: два на кінцях, і один в середину. Зразок включають в мостову схему:
до середнього контакту приєднують діагональ мосту, а дві половини зразка
слугують плечами мосту. Міст балансують, а потім освітлюють одну з половин
зразка вузькою смужкою світла, викликаючи цим розбалансування мосту. Проте
можна знайти таке положення світлового зонду, що міст знову збалансується.
Знаючи відстань від зонда до середнього контакту можна знайти час життя. Даний метод має свої обмеження, оскільки
використовується для зразків з часом життя не менше 10 мкс.
Методи стаціонарної фотопровідності. Метод визначення малих значень часу
життя при об’ємному збудженні [4]. Умови об’ємного збудження kL<1, kd<1. При ![]() з теорії випливає, що
з теорії випливає, що
![]() ,
(5)
,
(5)
де ![]() –
швидкість об’ємної генерації пар, см3/с.
–
швидкість об’ємної генерації пар, см3/с.
Для тонких зразків ![]() при високій
швидкості поверхневої рекомбінації на обох сторонах пластини [2]
при високій
швидкості поверхневої рекомбінації на обох сторонах пластини [2]
![]() . (6)
. (6)
Порівнюючи
величину фотовідповіді досліджуваного зразка, який має мале значення часу життя
(5) з фотовідповіддю еталонного зразка (6), можна знайти величину швидкості
об’ємної генерації та часу життя ![]()
![]()
Вимірювання часу життя за допомогою фотоелектромагнітного ефекту (ФЕМ – ефекту)
[2]. Суть
методу ФЕМ – ефекту полягає в наступному. Пластину напівпровідника освітлюють
променями світла, які створюють поверхневу генерацію носіїв струму. Пластину
поміщують в магнітне поле, силові лінії якого перпендикулярні довжині зразка та
направленню світла. Дифундуючи до неосвітленої сторони, пари носіїв заряду –
електрони і дірки – створюють ФЕМ – ефект. Таким чином, ФЕМ – ефект являє собою
ефект Холла, в якому збиткові носії створюються світлом. Напруга ФЕМ – ефекту
обумовлена дією сили Лоренца на дифузійний потік збиткових носіїв. По мірі
проходження носіїв в глибину зразка відбувається їх рекомбінація. При
накладанні магнітного поля інжектовані променями світла носії відхиляються в
сторону, перпендикулярну магнітному полю і світлу. В результаті цього виникає
напруга фотогальванічного ефекту ![]() , яка при малій інтенсивності світла і низькій
швидкості поверхневої рекомбінації описується співвідношенням [5]
, яка при малій інтенсивності світла і низькій
швидкості поверхневої рекомбінації описується співвідношенням [5]
 , (7)
, (7)
де ![]() ; H – напруга магнітного поля; d – товщина зразка; l –
довжина освітленої частини зразка або відстань між зондами; L – дифузійна довжина.
; H – напруга магнітного поля; d – товщина зразка; l –
довжина освітленої частини зразка або відстань між зондами; L – дифузійна довжина.
З цього співвідношення можна вирахувати
величину L, якщо відома інтенсивність
світла J. Величина UФЕМ не залежить від наявності в зразку рівнів
прилипання, оскільки носії заряду, які знаходяться на рівнях прилипання не
беруть участі в русі, та відповідно, не вносять вкладу в величину UФЕМ. Для визначення ![]() за допомогою ФЕМ
– ефекту потребуються однорідні зразки прямокутної форми з спеціально
приготовленими контактами.
за допомогою ФЕМ
– ефекту потребуються однорідні зразки прямокутної форми з спеціально
приготовленими контактами.
Вимірювання ФЕМ можна проводити різними
методами. При одному з них, вимірюють
абсолютну величину ЕРС ФЕМ – ефекту та розрахунок проводять за допомогою
формули [2]
 , (8)
, (8)
де UФЕМ – ЕРС ФЕМ; q – заряд електрона; А – швидкість поверхневої генерації пар;
l – довжина освітленої частини зразка; G=qAl – коефіцієнт,
який визначається по еталонних зразках при відсутності захвату.
При вимірюванні зразків з малим
значенням часу життя неосновних носіїв часто спостерігають розходження між
значеннями часу життя, виміряними по фотоелектромагнітному ефекту та
фотопровідності. Ці відмінності пов’язані з тим, що метод ФЕМ дозволяє
вимірювати час життя неосновних носіїв. По методу фотопровідності для
напівпровідника n і p – типу
вимірюється величина
[2]
 , (9)
, (9)
 . (10)
. (10)
При ![]() величина
величина ![]() . Але якщо відомі центри захоплення (прилипання),
. Але якщо відомі центри захоплення (прилипання), ![]() . Якщо в напівпровіднику n–типу на пастки захоплюється значна концентрація неосновних носіїв,
. Якщо в напівпровіднику n–типу на пастки захоплюється значна концентрація неосновних носіїв, ![]() , але оскільки,
, але оскільки, ![]() , то отримуємо
, то отримуємо ![]() та
та ![]() . Процес захоплення стає істотним при зниженні
температури, оскільки при високих температурах носії, захоплені пастками,
викидаються назад в зону. Для германію
інтенсивне захоплення починається при температурах нижче кімнатної, для кремнію
– нижче 100–150 оС.
. Процес захоплення стає істотним при зниженні
температури, оскільки при високих температурах носії, захоплені пастками,
викидаються назад в зону. Для германію
інтенсивне захоплення починається при температурах нижче кімнатної, для кремнію
– нижче 100–150 оС.
Явище захоплення відіграє значну роль при вимірюванні
малих значень часу життя, оскільки при цьому величина концентрації
нерівноважних носіїв заряду сильно зменшується та стає рівнозначною з
концентрацією центрів захоплення. При великих рівнях інжекції центри захвату
заповнюються носіями струму та не впливають на результати вимірювань. Метод
визначення τ по вимірюванню ФЕМ – ефекту широко використовується при
дослідженні рекомбінаційних параметрів великої кількості напівпровідників.
Вимірювання часу життя нестаціонарними методами. Нестаціонарні методи вимірювання часу
життя поділяються на дві групи. До першої групи можна віднести методи, в яких
вимірюється часове затухання збиткової концентрації носіїв струму після їх
інжекції. До другої групи відносяться фазові методи, в яких використовується
ефект фазового зсуву між сигналом фотопровідності та відповідним сигналом
генерації носіїв заряду.
Метод затухання фотопровідності. Основним фотоелектричним
методом є метод затухання фотопровідності, суть якого полягає в наступному.
Через пластину напівпровідника пропускають струм в режимі генератора струму. В
момент часу ![]() пластина
освітлюється коротким імпульсом світла за допомогою іскри від заряду
конденсатора. Після освітлення введені в зразок нерівноважні носії рекомбінують
в об’ємі та на поверхні напівпровідника. Досліджуючи закон затухання
фотопровідності на пластинах різної товщини та при різноманітній обробці
поверхні, можна визначити час життя неосновних носіїв заряду.
пластина
освітлюється коротким імпульсом світла за допомогою іскри від заряду
конденсатора. Після освітлення введені в зразок нерівноважні носії рекомбінують
в об’ємі та на поверхні напівпровідника. Досліджуючи закон затухання
фотопровідності на пластинах різної товщини та при різноманітній обробці
поверхні, можна визначити час життя неосновних носіїв заряду.
Розглянемо напівпровідник n – типу, в якому кількість центрів захоплення обмежено,
так що можна застосувати умову ![]() . Нехай інжекція світлом настільки короткочасна, що неосновні
носії не встигають продифундувати (за час імпульсу) до поверхні, тоді можна
прийняти, що в момент часу t=0 концентрація носіїв буде постійною у всьому об’ємі напівпровідника.
Приймемо, що товщина пластини
. Нехай інжекція світлом настільки короткочасна, що неосновні
носії не встигають продифундувати (за час імпульсу) до поверхні, тоді можна
прийняти, що в момент часу t=0 концентрація носіїв буде постійною у всьому об’ємі напівпровідника.
Приймемо, що товщина пластини![]() та
та ![]() ,
де
,
де ![]() та
та ![]() – відповідно ширина та довжина пластини. Для
того, щоб знайти закон затухання, необхідно вирішити рівняння неперервності:
– відповідно ширина та довжина пластини. Для
того, щоб знайти закон затухання, необхідно вирішити рівняння неперервності:
 , (11)
, (11)
при
початковій умові ![]() та при
граничних умовах
та при
граничних умовах
![]() , (12)
, (12)
де ![]() – швидкість
поверхневої рекомбінації (концентрацією рівноважних носіїв заряду можна
знехтувати).
– швидкість
поверхневої рекомбінації (концентрацією рівноважних носіїв заряду можна
знехтувати).
Сформульовану задачу можна вирішити
методом розділу змінних [2]:
 , (13)
, (13)
при чому
![]() являється коренями рівняння
являється коренями рівняння
 . (14)
. (14)
Величина провідності дорівнює
![]() .
.
Середня провідність, що не залежить від х, має вигляд [4]
 ,
,  , (15)
, (15)
де А та Аі – відповідні константи.
Таким чином, кінцеве розв'язок набуває
вигляду ряду, який складається з суми членів, кожний з яких затухає в часі по
експоненціальному закону. Збиткова концентрація носіїв через деякий проміжок
часу визначається членом з найменшим показником експоненти, тобто тим, який
включає величину ![]() [2]:
[2]:
 . (17)
. (17)
Таким чином, затухання стає чисто експоненціальним [2]:
 , (18)
, (18)
де  . (19)
. (19)
Знайшовши з даного виразу ![]() та підставивши його в рівняння (14), можна
отримати формулу, по якій визначається величина швидкості поверхневої
рекомбінації [1]:
та підставивши його в рівняння (14), можна
отримати формулу, по якій визначається величина швидкості поверхневої
рекомбінації [1]:
 . (20)
. (20)
Для вимірювання даним методом часу
життя носіїв при значеннях від декількох мікросекунд і вище [1], збиткові носії
генеруються за допомогою короткого імпульсу світла. Джерелом імпульсу являється
газорозрядна ксенонова лампа високого тиску, імпульсна лампа для фотоспалаху
або іскровий повітряний проміжок. По закінченні світлового імпульсу носії
рекомбінують по експоненціальному закону, по такому ж закону змінюється падіння
напруги на зразку. Освітлення зразка вузькою смужкою дає можливість визначити
рівномірність (однорідність) його по часу життя. Також в даному випадку
вимірюється ефективне значення часу життя.
Метод модуляції провідності в точковому
контакті. Метод дає можливість
виміряти час життя нерівноважних носіїв заряду у злитках напівпровідникових
матеріалів [2, 3]. Суть методу полягає в наступному: на поверхню злитка опускають точковий
контакт, який представляє собою емітер неосновних носіїв заряду; інший контакт
– омічний – має велику площу та малий опір. Через емітерний контакт в прямому
напрямку пропускають в режимі генератора струму два послідовних імпульси
струму, зсунуті один відносно іншого на час затримки t. Напругу,
яку знімають з омічного контакту подають на обмежувач імпульсів, а потім
спостерігають на екрані осцилографа. Різниця амплітуд першого та другого
імпульсів змінюється при зміні часу затримки по закону [2]:
 , (21)
, (21)
де ![]() – час життя. Границі
вимірювання часу життя у зразках германію та кремнію 3... 500 мкс при
питомому опорі 0,1...100 Ом·см, точність вимірювання порядку 30%.
– час життя. Границі
вимірювання часу життя у зразках германію та кремнію 3... 500 мкс при
питомому опорі 0,1...100 Ом·см, точність вимірювання порядку 30%.
Даний метод має ряд переваг по
відношенню до інших методів:
1) Вимірювання можна проводити на зразках різної форми та величини.
2) Результати вимірювання мало залежать від якості обробки поверхні зразка.
3) Центри захвату мало впливають на результати вимірів, тобто, вимірюване
значення відповідає часу життя неосновних носіїв заряду.
4) Можливо досліджувати залежність часу життя від рівня інжекції або від концентрації
неосновних носіїв.
Фазовий метод. Умова,
при якій збиткові носії не зникають миттєво після припинення дії інжектуючого
імпульсу, приводить при збудженні неосновних носіїв модульованим промінням до
виникнення фазового зсуву між сигналом фотопровідності та світлом, при чому фазовий
кут φ, який з’являється зв’язаний з часом життя та швидкістю поверхневої
рекомбінації. Таким чином, змінюючи кут φ, можна знайти час життя ![]() в досліджуваному зразку. В
найпростішому вигляді зміна провідності з часом при освітленні напівпровідника
синусоїдально модульованим промінням відбувається по закону [1]:
в досліджуваному зразку. В
найпростішому вигляді зміна провідності з часом при освітленні напівпровідника
синусоїдально модульованим промінням відбувається по закону [1]:
 , (22)
, (22)
де ![]() .
.
Вимірювання
часу життя при використанні електронно-діркових переходів (вимірювання
перехідних характеристик діодів) [4]. Даний метод заснований на спостережені зміни напруги на p-n переході з часом після прикладення до нього короткочасного імпульсу струму
в прямому напрямку. Під час прикладення імпульсу в прямому напрямку до p-n переходу в менш леговану область вводять збиткові носії струму. Якщо
обірвати імпульс, розімкнувши коло p-n переходу, то після початкового спаду
напруги U, яка
спадає лінійно з часом t слідує експоненціальний спад. За
лінійним спадом даної напруги можна визначити ефективний час життя в діоді за
формулою:
 . (23)
. (23)
Визначення
частотних і фазових характеристик. Час
життя можна також визначити за допомогою вимірювання частотної залежності
випрямленого струму в p-n переході [2]. Частотну залежність випрямленого струму можна пояснити існуванням ємності
p-n переходу, яка викликана інжекцією носіїв та струмом зміщення. При малих
рівнях інжекції частотна залежність випрямленого струму при навантажувальному
опорі, набагато більше диференціального опору діода, дорівнює [4]:
 (24)
(24)
та
при ![]() величина
величина![]() . Користуючись даним виразом обчислюють
. Користуючись даним виразом обчислюють ![]() в діоді. Метод
використовується для вимірювання часу життя порядку 10-7 с.
в діоді. Метод
використовується для вимірювання часу життя порядку 10-7 с.
На онові вище розглянутих методів на рис.1. представлена класифікація методів визначення часу життя носіїв
заряду.
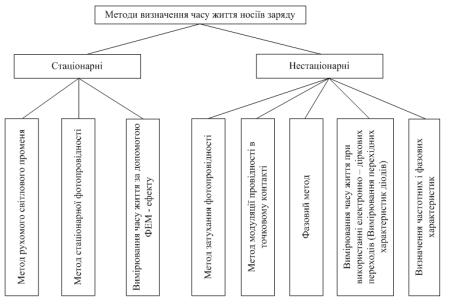
Рис. 1. Класифікація методів визначення часу життя носіїв заряду
Висновки
Найбільш перспективним методом
визначення часу життя носіїв заряду являється метод модуляції провідності в
точковому контакті, який володіє наступними перевагами: вимірювання можна
проводити на зразках різної форми та величини; результати вимірювання мало
залежать від якості обробки поверхні зразка;
центри захвату мало впливають на результати вимірів, тобто, вимірюване
значення відповідає часу життя неосновних носіїв заряду; можливо досліджувати
залежність часу життя від рівня інжекції або від концентрації неосновних
носіїв. Проте точність вимірювання часу життя носіїв заряду можна значно
покращити при використанні частотного методу, суть якого полягає в перетворенні
значення часу життя носіїв заряду у частоту.
Література
1. Блад П.
Методы измерения электрических свойств полупроводников/ П. Блад, Дж.В. Оргон – Зарубежная
радиоэлектроника, 1981. – 49 с.
2. Ковтонюк Н.Ф. Измерение параметров полупроводниковых материалов/
Н.Ф. Ковтонюк, Ю.А. Концевой – «Металургия», 1970. – 432 с.
3.
Павлов Л.П. Методы измерения параметров полупроводниковых материалов: Учеб. для
вузов по спец. «Полупроводниковые и микроэлектронные приборы»/ Л.П. Павлов. –
М.: Высш. шк., 1987. – 239 с.
4.
Батвин В.В. Измерение параметров полупроводниковых материалов и структур/ В.В.
Батвин, Ю.А. Концевой, Ю.В. Федорович. – М.: Радио и связь, 1985. – 264 с.
5. Рывкин С.М. Фотоэлектрические явления в полупроводниках/ С.М. Рывкин. –
Физматгиз., 1963. – 280 с.