Физика/2. Физика
твердого тела.
В.В. Скубо, П.Е. Сим, И.В. Федин
Научный руководитель Л.Э. Великовский
Томский государственный университет систем управления и
радиоэлектроники, 634050, Россия, г. Томск, пр. Ленина 40
Несплавные омические контакты к гетероструктурам на основе GaN. Образование
несплавных омических контактов
Аннотация
Данная статья является небольшим литературным
обзором достижений зарубежных ученых в области получения несплавных омических
контактов к гетероструктурам на основе GaN. В частности
рассмотрено образование несплавных омических контактов.
Введение
В микроэлектронике давно известно, что характеристики
приборов на основе гетероструктур AlGaN/GaN
существенно зависят от свойств омических контактов (ОК) к полупроводнику.
Поэтому исследованию влияния различных технологических факторов на формирование
параметров ОК на гетероструктуре AlGaN/GaN,
уделяется пристальное внимание. Задача получения ОК к n-GaN с
минимальными значениями контактного сопротивления, линейной вольт-амперной
характеристикой, а также устойчивых к термическим воздействиям, является
актуальной и остается не решенной до настоящего времени.
Самым распространенным типом металлизации
омических контактов являются металлические структуры вида Ti/Al/Барьерный
слой/Au, в качестве барьерного слоя выступает один из металлов: Pt, Ni, Ti, Mo. С
целью улучшения характеристик омических
контактов проводится высокотемпературный отжиг (сплавление) контактов.
Однако в процессе высокотемпературного отжига проявляется
ряд негативных процессов (накопление поверхностных дефектов, проблема
надежности, сильная боковая диффузия контактирующих металлов и т.п.),
ограничивающих возможность формирования низкоомных омических контактов.
Для решения этих проблем используются несплавные
омические контакты, которые напыляются непосредственно на сильнолегированные
области гетероструктуры. Несплавные
омические контакты не требуют термического отжига, характеризуются гладкой
морфологией поверхности и равномерным распределением сопротивления по
контактной площадке [1].
Образование
несплавных омических контактов
Для формирования несплавных омических контактов
необходимы такие технологические операции как: эпитаксия, литография с двухслойной
маской, осаждение металлов, травление и быстрый термический отжиг.
На рис. 1 представлена последовательность
операций формирования несплавных омических контактов к гетероструктуре на
основе GaN.
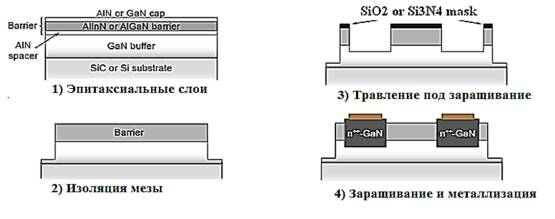
Рисунок 1. Этапы формирования несплавных
омических контактов
Для получения высоколегированных слоев в области
омического контакта вытравливают углубление методом реактивного ионного
травления на глубину 70-100 нм, при этом используется резистивная маска из SiO2 или Si3N4,
толщина
которой варьируется в диапазоне 20÷100 нм. Высоколегированные области
можно выращивать двумя способами: молекулярно-лучевой или МОС-гидридной
эпитаксией. Толщина выращиваемых областей колеблется в пределах от 30 нм до 200
нм.
Перед напылением металлизации поверхность
пластин подвергается различным обработкам, которые в дальнейшем влияют на
контактное сопротивление и качество получаемых контактов [2].
После анализа зарубежной литературы были
выделены самые распространенные комбинации металлов для несплавных омических
контактов: Ti/Au и Ti/Au/Ni [3-5].
Литература
1 L. Pang,
K. Kim. Analysis of AlGaN/GaN high electron mobility transistors with nonalloyed
Ohmic contacts achieved by selective area growth using plasma assisted
molecular beam epitaxy, J. of Engineering, Vol. 04 (2), 2014, 8-13.
2 L.F. Lester,
J.M. Brown, J.C. Ramer, L. Zhang, S.D. Hersee. Nonalloyed Ti/Al Ohmic contacts
to n-type GaN using high-temperature premetallization anneal, Appl. Phys. Left.
Vol. 69 (18), 1996, 2737-2739.
3 F. Recht, L.
McCarthy, S. Rajan, A. Chakraborty, C. Poblenz, A. Corrion, J.S. Speck, U.K.
Mishra. Nonalloyed Ohmic Contacts in AlGaN/GaN HEMTs by Ion Implantation With
Reduced Activation Annealing Temperature, IEEE. Vol. 27 (4), 2006, 205-207.
4 M. H. Wong, Y.
Pei, T. Palacios, L. Shen, A. Chakraborty et al. Low nonalloyed Ohmic contact
resistance to nitride high electron mobility transistors using N-face growth,
Appl. Phys. Left. Vol. 91, 2007, 1-3.
5 D. F. Brown, K.
Shinohara, A.L. Corrion, R. Chu, A. Williams, J.C. Wong. High-Speed,
Enhancement-Mode GaN Power Switch With Regrown n+ GaN Ohmic Contacts and Staircase Field Plates,
IEEE, Vol. 34 (9), 2013, 1118-1120.