Пагава Т.А., Беридзе М.Г., Чхартишвили Л.С.,
Майсурадзе
Н.И.,
Бжалава Т.Л., Каландадзе И.Г.,
Харшиладзе Н.Ш., Деканосидзе Ш.В.
Грузинский технический университет, Грузия
Влияние фотовозбуждения на
подвижность
электронов в кристаллах n-Si, облученных высокоэнергетическими
протонами
Исследуемые образцы монокристаллов n-Si с
концентрацией электронов N=6×1013см–3, облучались протонами с
энергией 25МэВ при 300K. Для
исследования применяли метод фото-Холл-эффекта. В облученных образцах наблюдается
аномально высокое значение холловской подвижности электронов, что объясняется
образованием в кристалле высокопроводящих включений с омическим переходом на
границе с матрицей кристалла. При некоторых температурах изохронного отжига
(ИО) наблюдается аномально высокое рассеяние электронов, которое уменьшается
монохроматической ИК подсветкой заданной энергий. Подсветка деионизирует
электростатически взаимодействующие вторичные глубокие центры, которые
образуются в процессе изохронного отжига вокруг металлических включений и
экранируют их. Показано, что экранирующими дефектами, которые образуются
вокруг металлических включении, являются А- и Е- центры.
1. Введение
В кристаллах кремния при облучении
частицами высоких энергий (Е ³ 10МэВ), помимо точечных дефектов, образуются
макроскопические повреждения кристаллической решетки, т.н. разупорядоченные
области (РО). Ядра РО состоят из вакансий, дивакансий и различного рода вакансионных
ассоциатов, а в формировании ее периферии (оболочки) участвуют дефекты типа
примесь + вакансия. РО в n-Si характеризуются проводимостью р-типа, а в p-Si – n-типа, т.е. они являются диэлектрическими включениями
и вызывают уменьшение эффективного значения µэфф.
холловской подвижности µH,
как в области фононного рассеяния, так и в области рассеяния на заряженных
дефектах [1–5]. Авторами работ [4,5] было высказано предположение, что ядра РО
состоят из собственных межузельных атомов.
В работах [6–8] экспериментально показано,
что в кристаллах n-Si, облученных протонами с энергией 25МэВ
преимущественно образуются металлические включения с омическим переходом на
границе раздела с матрицей полупроводника, что приводит к аномальному
увеличения µэфф.. В процессе изохронного отжига вокруг
металлических включений (которые по-видимому, являются скоплениями
межузельных атомов) образуется непрозрачная для электронов проводимости
оболочка из отрицательно заряженных акцепторных радиационных дефектов (РД),
чем объясняется резкое уменьшение µэфф после отжига
облученных образцов при Tотж.=110°C и в процессе
естественного старения в течение 30 суток при 300K. Источником неравновесных вакансий, по-видимому,
являются дефекты вакансионного типа с низкой термостабильностью [3,5].
В работе [8] высказано предположение, что
в области высоких температур (300–200K) за
экранирование металлических включений ответственны Е-центры, а при низких
температурах кроме Е-центров – также
А-центры, которые начинают заряжаться ниже 200 K. После отжига Е-центров (Tотж.=160°C) экранирующая оболочка при низких температурах
(<200K), по-видимому, состоит только из отрицательно
заряженных А-центров. Если в атмосфере вокруг металлических включений
действительно образуются А- и Е-центры и если именно они ответственны за резкое
уменьшение µэфф. электронов в кристаллах n-Si, облученных
протонами с энергией 25МэВ, то, используя монохроматическую селективную
подсветку, можно существенно повлиять на вид кривой µэфф.(T) путем деионизаций определенного числа этих центров.
Целью данной работы является изучение
влияния селективного фотовозбуждения, с помощью ИК подсветки, части А- и
Е-центров на µH в
исследуемых образцах.
2. Эксперимент
Для исследования нами были использованы
монокристаллы n-Si, легированные фосфором, с концентрацией электронов N=6×1013см–3. Кристаллы были
получены методом зонной плавки. Соответственно концентрация кислорода NO»1016см–3, а плотность ростовых
дислокаций Nдис.»103–104см–2.
Для изучения роли деионизаций глубоких
центров на µэфф. мы использовали метод фото-Холл-эффекта:
электроны с уровней данного типа возбуждались в зону проводимости светом с
помощью монохроматора ИКС–21. ИК свет от одного монохроматора освещала только
определенную часть исследуемого образца. Для усиления эффекта мы кристалл
освещали из двух источников, таким образом, что они не перекрывали друг друга.
В этих условиях уровень инжекций фотоносителей не превышала 2–3%.
Температурная зависимость N и µэфф.
исследовалась в интервале T=77–300K. Измерения проводились компенсационным методом в
магнитном поле H=10кЭ; холловский фактор
принимался равным единице. С целью осуществления перестройки атмосферы точечных
дефектов, образующихся вокруг металлических включенний, применялся ИО в
интервале 80–400°C, шагом 10°C с охлаждением за время £10 сек; время выдержки при фиксированной температуре
10 мин. Погрешность измерения этих величин не превышала 10%.
3. Результаты исследований и их
обсуждение
На рис.1 представлены зависимости µэфф.(T) в исходном кристалле (кр.1), после облучения протонами с энергией 25МэВ,
интегральным потоком равным 8×1012см–2 (кр.2), а также после
отжигов при Tотж.=110,
160, 380 и 400°С (кр.3, 4, 7 и 8, соответственно). На кр.3 наблюдается резкое
уменьшение µэфф. с минимумом при 180K, а на кр.4 – при 100K.
Возбуждение электронов в зону проводимости
с уровня 0,44эВ (длина волны λ=2,8мкм), в образцах отожженных при Tотж.=110°C, увеличивает значение µэфф., немного
смещая его в сторону меньших температур (рис.1, кр.5). После Tотж.=160°C возбуждение электронов с уровней 0,17эВ (λ=7,3мкм),
вызывает увеличение максимума на кривой зависимости µэфф.(T) и смещает его 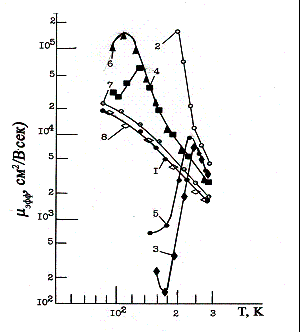 в сторону более низких температур (кр.6).
в сторону более низких температур (кр.6).
Рис.1. Зависимость подвижности электронов от
температуры в облученных кристаллах n-Si: 1 – до облучения; 2 – после облучения; 3, 4, 7, 8 –
после отжигов при 110, 160, 380 и 400°С, соответственно; 5, 6 – при подсветке
кристаллов ИК светом с энергиями фотонов 0,44 и 0,17эВ, отоженных при 110 и
160°С, соответственно.
Из рис.1 следует, что подсветка оказывает
влияние на ход зависимости µэфф.(T) не только при низких температурах (~100K), в области рассеяния электронов
на заряженных центрах, но и фононах (³180K).
Энергия электрона на локальном уровне Е=ЕТ+ε,
где ЕТ – тепловая
энергия, а ε – энергия электростатического взаимодействия между
отрицательно заряженными дефектами в атмосфере вокруг металлических
включений. Если Е=Еi,
где Ei – энергия деионизаций центра, то электрон из
локального уровня переходит в зону
проводимости. По-видимому, в интервале 230–300K электроны с уровня Е=Еi=0,44эВ, соответствующего Е-центрам, переходят в зону
проводимости, степень экранирования металлических включений уменьшается и
холловская подвижность, согласно [6], может быть представлена выражением:
µэфф. » µH
(1 + 3f1) / (1 – 6f1), (1)
где µH – холловская подвижность неповрежденной матрице, а f1 –
суммарная объемная доля скоплений межузельных атомов. Как видно из формулы
(1), µэфф. является возрастающей функцией объемной доли f1
включений, что мы наблюдаем на кривой зависимости µэфф.(T) в интервале 230–300K (кр.3). С понижением температуры Е
уменьшается и Е-центры начинают заряжаться. Следовательно, увеличивается
степень экранирования металлических включении. Они становятся непразрочными для
электронов и, согласно [2], холловская подвижность уменьшается по закону:
µэфф. » µH
(1 + f2 /4) / (1
– f2 /2), (2)
где µH – холловская подвижность электронов в исходном
образце, f2 – доля объема, занимаемая диэлектрическими включениями
(рис.1, кр.2).
Следует отметить, что в данном случае
кроме энергии и дозы облучения, f1 и f2 являются также функциями степени экранирования
металлических включений η. При увеличений η, f1
уменьшается, а f2 увеличивается и наоборот.
На кривой зависимости µэфф.(T) в области 180K наблюдается минимум (кр.3). Существование минимума в
работе [4] объясняется изменением степени экранирования металлических
включений, входящей в зависимость от температуры, в процессе измерения. Хотя
единого мнения по этому вопросу в научной литературе пока нет [7–12].
Увеличение значения µэфф.
в интервале 140–230K при возбуждений электронов в
зону проводимости с уровня ЕС–0,44эВ, используя ИК подсветку,
объясняется уменьшением степени экранирования атомных кластеров и соответственно
увеличением объемной доли металлических включений f1 (см. формулу
(1)). В температурном интервале 230–300K Е-центры истощенны в силу электростатического
взаимодействия и высокой температуры. Поэтому
ИК подсветка не влияет на величину µэфф..
А-центры в области фононного рассеяния
(300–200K) практически электронейтральны и никак не могут
повлиять на степень экранирования металлических включений и соответственно на
µэфф..
Что касается дивакансиям, они образуются в
процессе облучения путем каскадного механизма и несомненно присутствуют в
объеме кристалла. В процессе ИО, в силу электростатического отталкивания между
отрицательными моновакансиями, образование дивакансий путем диффузионного
механизма маловероятно. Поэтому в атмосфере вокруг металлических включений, по
всей вероятности, они присутствуют в небольшом количестве.
Уменьшение µэфф. в
области низких температур (130K) после полного
отжига Е-центров (Tотж.=160°C) в работе [8]
объясняется изменением зарядового состояния А-центров. Они заряжаются
отрицательно и увеличивают степень экранирования металлических включений. В
этом температурном интервале металлические включения с отрицательно заряженной
оболочкой, на µэфф. влияют двояко: с одной стороны, как
квазидиэлектрические включения, блокируя потоки электронов, они уменьшают
фактический объема кристалла, а с другой – в виде электрического эффекта,
проявляющегося в дополнительном рассеянии электронов в поле отрицательного
заряда, окружающем металлические включения. Оба эти эффекта приводят к
уменьшению µэфф..
Возбуждение электронов в зону проводимости
с уровня ЕС–0,17эВ с помощью ИК подсветки, приводит к
уменьшению степени экранирования металлических включений η. В
результате уменьшается влияние обоих эффектов на µэфф. –
имеет иесто блокирование и рассеяние потока электронов отрицательно заряженными
включениями. Следовательно µэфф. продолжает расти почти до
100K, а минимум, по-видимому, смещен влево, в области
низких температур (Т<77K).
После полного отжига А-центров при Tотж.=400°C кривая зависимости µэфф. в
интервале температур от комнатной до точки кипения азота меняется монотонно
(кр.8).
4. Заключение
Для уточнения, какие именно радиационные
дефекты ответственны за уменьшение
холловской подвижности µэфф. в облученных протонами с
энергией 25МэВ кристаллах n-Si при различных температурах, был использован метод
фото-Холл-эффекта.
Исследование показало, что на селективное
возбуждение Е-центров (с уровнем ЕС–0,44эВ) реагирует минимум
на кривой зависимости µэфф.(T) в области 180K, а на возбуждение А-центров – минимум при 100K.
Полученные результаты подтверждают
существующее мнение о том, что экранирование металлических включений в
облученных протонами кристаллах n-Si в области фононного рассеяния происходит только
Е-центрами, а при низких низких температурах Е- и А-центрами. После полного
отжига Е-центров (Tотж.=400°C) за
существование минимума на кривой зависимости µэфф. ответственны
только А-центры.
Литература
1. B.R. Gossik. J.Appl. Phys., 1959, 30, 1214.
2. З.Ф. Коноплева, В.Л. Литвинов, Н.А. Ухин.
Особенности радиационного повреждения полупроводников частицами высоких
энергий. 1971, М.: Атомиздат.
3. Н.А. Ухин. ФТП, 1972, 6, 831.
4. В.И. Кузнецов, П.Ф. Лугаков. ФТП, 1979, 13,
625.
5. В.И. Кузнецов, П.Ф. Лугаков. ФТП, 1980, 14,
1980.
6. Т.А. Пагава, Н.И. Майсурадзе. ФТП, 2010, 44,
160.
7. Т.А. Пагава, Н.И. Майсурадзе, М.Г. Беридзе. ФТП, 2011, 45, 582.
8. Т.А. Пагава, М.Г. Беридзе, Н.И. Майсурадзе. ФТП,
2012, 46, 1274.
9. Е. В. Кучис. Гальваномагнитные эффекты и
методы их исследования. 1990, М.: Радио и связь.
10. С.В. Безлюдный, И.В. Колесников. ФТП, 1976, 10,
1964.
11. Т.А. Пагава, Л.С. Чхартишвили. УФЖ, 2003, 48, 232.
12. Л.С. Милевский, Т.М. Ткачева, Т.А. Пагава. ЖЭТФ,
1975, 69, 2132.