О. В. Боцула, Э. Д. Прохоров, А. В.
Суздальцев, А. В. Дядченко
Харьковский национальный университет
им.В.Н.Каразина,
РЕЗОНАНСНО-ТУННЕЛЬНЫЕ ДИОДЫ НА ОСНОВЕ AlN/AlxGa1-xN
Цель
настоящей работы — исследовать возможности использования в качестве материалов
для РТД соединений на основе азота AlN, GaN.
Материалы
на основе азота начали находить применение сравнительно недавно. Поэтому и
параметры двойных соединений, не говоря уже о тройных соединениях InGaN, AlGaN,
известны недостаточно точно. Однако, в литературе имеются сведения, которые
необходимы для расчета резонансно-туннельных диодов на основе этих соединений
[1].
Отличительной особенностью
рассматриваемых соединений является большая ширина запрещенной зоны и высота
потенциальных барьеров в резонансно-туннельных структурах на их основе.
По
известной методике [2,3] были
определены для различных составов соединений высоты потенциальных барьеров РТД
W, энергетические уровни в РТД с различной высотой потенциальных барьеров,
коэффициенты прозрачности D для каждого из уровней, вольтамперные
характеристики РТД и эффективность генерации РТД на различных энергетических
уровнях.
Исследовались РТД, в которых в качестве
квантовой ямы использовались соединения AlxGa1-xN, а в
качестве потенциальных барьеров AlN.
Таблица
1. Параметры РТД с различными составами
соединений.
|
№ |
Соединение |
X |
m*n |
Высота бар. (эВ) |
|
1 |
AlN/GaN |
- |
0,2 |
2,3885 |
|
2 |
AlN/AlxGa1-xN |
0,1 |
0,2 |
2,2525 |
|
3 |
AlN/AlxGa1-xN |
0,2 |
0,2 |
1,9975 |
|
4 |
AlN/AlxGa1-xN |
0,3 |
0,2 |
1,7425 |
|
5 |
AlN/AlxGa1-xN |
0,4 |
0,2 |
1,53 |
Барьеры образованы слаболегированным
широкозонным полупроводником AlN, с толщиной b, квантовая яма шириной а
образована AlxGa1-xN, слева и справа от барьеров сильнолегированный n+- AlxGa1-xN
c концентрацией примесей 5×1017…1018см-3
и омическими контактами. Высоты потенциальных барьеров в зоне проводимости
определяются разрывом зоны проводимости гетероперехода AlN/AlxGa1-xN
и с использованием правила Дингла составляют значения, приведенные в таблице 1.
Толщины слоев составляют а » 5 нм, b » 1...3 нм. В
этом случае в квантовой яме оказывается несколько энергетических уровней, значения которых зависят от эффективной массы
электрона и ширины ямы. Полученные значения энергетических уровней для AlN/GaN следующие:
ε1=0,0675
эВ; ε2=0,27
эВ; ε3=0,6075 эВ; ε4=1,08
эВ. e5 =1,6875 эВ. Расчитанная вольтамперная
характеристика РТД с наиболее высокими потенциальными барьерами показана на
рис.1.
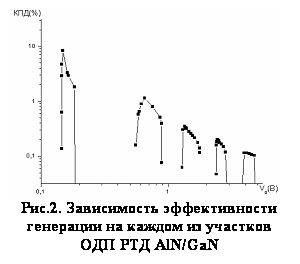 На
фоне общего нарастания тока через структуру хорошо видны резонансные пики тока,
соответствующие каждому из резонансных уровней. С увеличением номера
энергетического уровня максимальный ток в пике растет и превышает ток первого
пика на несколько порядков (рис. 1)
На
фоне общего нарастания тока через структуру хорошо видны резонансные пики тока,
соответствующие каждому из резонансных уровней. С увеличением номера
энергетического уровня максимальный ток в пике растет и превышает ток первого
пика на несколько порядков (рис. 1)
 С
каждым пиком ВАХ связан участок с
отрицательной дифференциальной проводимости, который следует за участком роста
тока. Как видно из полученных характеристик величина тока в максимумах ВАХ
увеличивается с возрастанием номера энергетического уровня, причем при
толщинах барьера 2 нм и более первые
максимумы проявляются слабо. С уменьшением
толщины барьеров происходит возрастание общего тока через диод. Ток в максимумах
вольтамперной характеристики также возрастает и первые максимумы
становятся более заметными.
С
каждым пиком ВАХ связан участок с
отрицательной дифференциальной проводимости, который следует за участком роста
тока. Как видно из полученных характеристик величина тока в максимумах ВАХ
увеличивается с возрастанием номера энергетического уровня, причем при
толщинах барьера 2 нм и более первые
максимумы проявляются слабо. С уменьшением
толщины барьеров происходит возрастание общего тока через диод. Ток в максимумах
вольтамперной характеристики также возрастает и первые максимумы
становятся более заметными.
Рассчитанные
зависимости эффективности генерации от
напряжения смещения приведены на рис. 2 для РТД на
основе гетеропары AlN/GaN.
Среди
рассмотренных соединений наибольший КПД
получается при использовании РТД на основе
AlN/AlxGa1-xN при
доле алюминия ![]() 0,4 . Данная структура
является четырехуровневой.
0,4 . Данная структура
является четырехуровневой.
Во всех рассмотренных РТД эффектиность генерации имеет наибольшее
значение на первом участке ОДП. Это
обусловено малыми значением напряжения смещения для первого участка и вместе с
тем достаточно высокой контрастностью ВАХ на этом участке. Для рассмотренных
РТД можно определить оптимальное значение высоты барьера (1,53 эВ) в соединении
AlN/Al0,4Ga0,6N,
как наиболее подходящее для использования в РТД.
В
результате проделанной работы можно сделать следующие выводы:
1. Используя пары AlN/AlxGa1-xN,
где доля х меняется от 0 до 0,5 можно получить РТД с 2, 3, 4, 5-ю уровнями в
квантовой яме. Такие структуры имеют участки роста тока и следующие за ними
участки ОДП, число которых соответствует числу уровней в квантовой яме.
2. Показано, что эффективность генерации на каждом из
участков ОДП зависит от параметров резонансно-туннельного диода и ширины
потенциальных барьеров и может составлять до 10% на первом максимуме.
ЛИТЕРАТУРА
1. Bhapkar U. V.,Shur
M. S. Monte Carlo calculation of velocity field characteristic of GaN,
J.Appl.Phys., 1997, 82(4), pp.1649-1655.
2. Прохоров Э. Д.,
Квантово-размерные эффекты в твердотельных сверхвысокочастотных приборах:-Х:
ХНУ имени В.Н. Каразина.-2005.-220с.
3. Боцула О. В., Прохоров Э. Д., Особенности совместной
работы резонансно-туннельного диода и диода Ганна, Радиофизика и электроника, сб. научн. трудов
ИРЭ НАНУ, 2002, т.7, №3, 527-531.