Технические
науки / Электротехника и радиоэлектроника
Осадчук В.С.,
Осадчук О.В., Мартинюк В.В., Стовбчата О.П.
Вінницький національний технічний університет
Огляд магнітних сенсорів на основі магнітодіодного ефекту
Під магнітодіодним
ефектом розуміють різку зміну електричного опору напівпровідникового діода з
довгою базою, увімкненого в прямому напрямку, у результаті дії на діод поперечного
магнітного поля [1]. Для пояснення цього ефекту
розглянемо явища, що виникають у діоді, зображеному на
рис. 1.
Він має p-n-перехід,
тобто контакт напівпровідників з електронною і дірковою провідністю в одному
монокристалі. Перехід у цьому випадку несиметричний – концентрація рівноважних носіїв у p-області значно більша, ніж у n-області, тобто n-область є більш високоомною, ніж
p-область.

Рис. 1. Структура магнітодіода
Під час приєднання до
р-напівпровідника позитивного полюса зовнішнього
джерела живлення, а до n-напівпровідника – негативного відбувається інжекція
дірок із р-області в n-область. Внаслідок цього в обох частинах p-n-переходу почне відповідно зростати концентрація електронів і дірок. Якщо рівень інжекції достатньо
високий, то провідність n-області буде визначатися концентрацією нерівноважних
носіїв. Інжектовані дірки дифундують
від p-n-переходу всередину n-напівпровідника на деяку відстань L, яка
називається дифузійною довжиною. На цій
відстані концентрація нерівноважних носіїв зменшується внаслідок рекомбінації в e раз. При високих рівнях
інжекції [2]
![]()
де
b = μn/μp
- відношення рухливостей електронів і дірок: τ - час життя носіїв; Deff
- коефіцієнт спільної дифузії.
Внесок нерівноважних носіїв струму в
електропровідність n-області сильно залежить від
значення дифузійної довжини. Чим менше L, тим менша концентрація нерівноважних носіїв струму в n-напівпровіднику і
тим більший його опір. Якщо розташувати досліджуваний діод
в поперечному магнітному полі, то коефіцієнт
дифузії Deff нерівноважних носіїв струму
зменшиться внаслідок викривлення траєкторії
руху носіїв під дією сили Лоренца. Вплив
магнітного поля тут особливо значний, оскільки при спільній дифузії нерівноважних електронно-діркових пар
практично відсутнє поле Холла, яке могло б частково компенсувати викривлення
траєкторії. Тому поперечне магнітне
поле викликає зменшення дифузійної довжини, а отже, і зростання опору n-області. Вплив зменшення L на зростання опору
довгої n-області досягає максимуму при деякому значенні співвідношення d/L, де d - довжина
n-області. Для германію, наприклад, оптимальне значення d/L = 4...6.
Отже, при дії поперечного магнітного поля на діод (рис.
1), через який протікає достатньо великий прямий струм,
дифузійна довжина інжектованих у n-напівпровідник
дірок зменшується. Це, у свою чергу викликає збільшення опору
n-напівпровідника і, як наслідок, перерозподіл напруги U0
(що спадає на p-n-переході) і напруги Un (що спадає
на n-області): Un, зростає, а U0 зменшується, причому U0 + Un = const. Зменшення напруги на
p-n-переході призведе до зменшення інжекції дірок із p-n-переходу і до нового
збільшення опору n-напівпровідника. Останнє викликає
новий перерозподіл напруги, нове зменшення інжекції і
т.д. У результаті мале початкове зменшення дифузійної довжини в магнітному полі призводить до дуже сильного зменшення прямого струму через діод (внаслідок різкого зменшення середньої
концентрації нерівноважних носіїв струму).
При розташуванні діода з довгою базою у магнітному полі
паралельно його подовжній осі, інжектовані в базу електрони і дірки починають
обертатися навколо осі в перпендикулярній площині [3]. При цьому відбувається
утворення згустків плазми, що чергуються зі збідненими областями. Якщо на
бічних гранях діода встановити два симетричних зонди (типу
холлівських контактів), то обертання згустків і
збіднених областей плазми в перпендикулярній площині приведе до появи змінної ЕРС між зондами. Коливання струму, що протікає через діод симетричної структури, при цьому не відбувається, тому що перерозподіл плазми в
перпендикулярній площині не змінює сумарної концентрації і загального опору. При порушенні симетрії розподілу вихідної концентрації носіїв заряду щодо осі (зміною швидкості поверхневої рекомбінації на одній
грані, бічним підсвічуванням і т.д.) виникнення
змінної ЕРС на поперечних зондах супроводжується виникненням
коливань струму, що протікає через діод.
У роботі [4] розглядається магнітодіод, конструкція якого представлена
на рис. 2. Магнітодіод містить пластину з напівпровідникового матеріалу з S – подібною
вольт-амперною характеристикою. До пластини примикають інжектований і омічний
лінійні контакти. З метою підвищення чутливості до магнітного поля, один з
контактів виконаний у виді рівнобедреного трикутника з вершиною, спрямованого в
глибину бази магнітодіода. Зменшення рухливості носіїв заряду відбувається за
рахунок накладення магнітного поля, що викликає збільшення опору бази з
відповідним перерозподілом прикладеного до діода напруги між p-n-переходом і
товщею бази. При цьому зменшення напруги на p-n-переході сприяє зменшенню
інжекції, тобто концентрації інжектованих у базу носіїв і, їхнього часу життя.
Що приводить до нового збільшення опору бази і зменшенню струму через діод
(тобто підвищенню напруги на діоді при заданому струмі через нього).
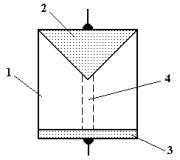
Рис. 2. Конструкція магнітодіода: 1 –
пластина з напівпровідникового матеріалу (кремній, германій, арсенід галію); 2, 3 – контакти; 4 – шнур високої густини струму
На рис. 3 приведена одна із структур інтегрального магнітодіода,
виготовленого з використанням типової МОП технології. Область емітера 1 і контакт до колектора 2 магнітодіода
реалізовані на основі n+ областей
стоку-витоку n МОП транзистора,
базова область 3 формується на основі дифузійної області кишені р-типу, контакт
до базової області 4 – на основі р+ областей стоку-витоку р МОП транзистора,
колектором є підкладка n-типу. В даній конструкції межа розділу оксид-кремній 5 грає роль поверхні з низкою
швидкістю рекомбінації, а зворотно зміщений р-n-перехід база-колектор – роль
поверхні з високою швидкістю рекомбінації носіїв заряду.

Рис. 3. Структура
магнітодіода
Відмітні особливості даного приладу: магніточутливий
елемент ефективно працює при високому рівні інжекції; корисний сигнал
знімається між електродами емітер-база [5]. У роботі [6] запропонована
оригінальна конструкція магнітодіода, виготовленого за технологією «кремній на
сапфірі» (КНС). На рис. 4 приведений один з варіантів структури такого приладу.
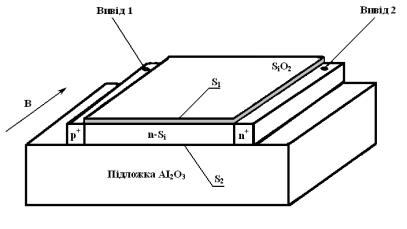
Рис. 4. Структура
магнітодіода, виготовленого за технологією
«кремній на сапфірі»
Електрони і дірки з n+ і р+ областей інжектуються в слабко леговану n-область, де вони дрейфують під впливом електричного поля.
Поверхня розділу (Si-SiO2) в пластині
має низьку швидкість рекомбінації S, в
порівнянні з швидкістю рекомбінації S2 нижньої межі розділу (Si-Al2O3).
Магнітне поле в площині відхиляє носії заряду до однієї з площин і у
вольтамперної характеристиці відбуваються відповідні зміни. Прилад має високу
магнітну чутливість; проте є і деякі недоліки. Основним недоліком вважається
сильна нелінійність енергетичної характеристики чутливості, яка залежить від
напряму впливаючого магнітного поля. Додаткові проблеми створює велика
залежність параметрів приладу від температури [6].
З
появою халькогенідного напівпровідникового скла були розроблені магнітодіоди,
що володіють специфічними характеристиками [7]. Дія магнітодіодів базується на
використанні оригінальних властивостей халькогенідного скла. Шари
халькогенідного напівпровідникового скла, якщо їх помістити між металевими
електродами, володіють симетричними вольт-амперними характеристиками з
ділянками негативного опору, що розділяють два можливі стійкі стани –
високоомий і низькоомний. При певних складах халькогенідного скла такі
структури після переходу в низькоомний стан залишаються в ньому і після зняття
напруги зсуву, тобто в них спостерігається ефект «пам’яті». Перепад опорів у
високоомному і низькоомному стані може перевищувати 3–4 порядки при відношенні
порогової напруги до залишкової до 10-50 разів. Ефекти перемикання і «пам’яті»
визначаються об’ємними процесами і не пов’язані з існуванням р-n або
гетеропереходів.
На рис. 5 показана структура магнітодіода з
аморфно–кристалічним гетеропереходом, реалізована на базі структур вітчизняних
магнітодіодів типу КДЗОЗ. На рис. 6 приведена вольт-амперна характеристика
такого діода [7].
Порогова напруженість електричного поля, що забезпечує
перемикання приладу в провідний стан, дорівнює 105-106
В/см. Час перемикання – близько 10-9с при часі затримки близько 10-6с.
Напруга перемикання, залишкова напруга і опір структури в низькоомному стані
сильно залежать від індукції керуючого магнітного поля. Вольтамперні
характеристики таких магнітодіодів на основі КД304А-1 – КД304Ж-1 симетричні і
дані на рис. 6.

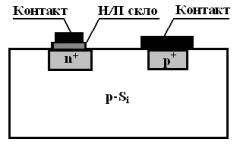
|
Рис. 5. Структура
магнітодіода з аморфно-кристалічним гетеропереходом: на базі КД303А – КД303Ж |
Рис. 6. Симетричні ВАХ магнітодіода з пороговим перемиканням при
відсутності магнітного поля В і в полі з В = 0,3 Тл |
Головним недоліком магнітодіодів є низька температура експлуатації – до +85
оС.
Література
1. Викулин И. М.
Гальваномагнитные приборы / И. М. Викулин, Л. Ф. Викулина, В. И. Стафеев. – М.:
Радио и связь, 1983. – 104 с.
2. Мікроелектронні
сенсори фізичних величин / За ред. З. Ю. Готри. – Львів: Ліга-Прес, 2002. – 475 с.
3. Осадчук В.
С. Сенсори тиску і магнітного поля / В. С. Осадчук, О. В. Осадчук. – Вінниця: «УНІВЕРСУМ–Вінниця», 2005. – 207
с.
4. Чаплыгин
Ю.А. Введение в технологию кремниевых микроэлектронных датчиков. Учебное
пособие / Ю.А.Чаплыгин, А.И.Галушков. –М.:МИЭТ, 1996. –62с.
5. Кордич
С. Интегральные кремниевые датчики магнитного поля / С. Кордич // Sensors &
Actuators. – 1986. – № 10. – Р. 34–78.
6. Егиазарян
Г. А. Магнитодиоды, магнитотранзисторы и их применение /
Г. А. Егиазарян, В. И. Стафеев. – М.: Радио и Связь, 1987. – 88 с.
7. Стафеев В.И. Магнитодиоды / В. И. Стафеев,
Э. И. Каракушан. – М.: Наука. 1975. – 216 с.