УДК 621.383.522+621.793
Галочкін О.В., Ащеулов
А.А., Захарук І.М., Дремлюженко С.Г.,
Даналакій О.Г., Романюк І.С.
Технологічні особливості
виготовлення та параметри фотодіодних структур на основі напівпровідників A2B6
В роботі представлена
лазерна технологія створення фотодіодних структур на CdTe та CdMnTe, які
характеризуються фоточутливістю в області спектру 0,5-0,91 мкм та спектральною
чутливістю в максимумі Sl=0,38-0,43 А/Вт.
Запропонована методика створення стабільних омічних контактів на цих структурах
із застосуванням лазерної пасивації поверхні. Проведені виміри електричних та
фотоелектричних параметрів цих фотодіодів. Встановлено, що такі структури
володіють генераційно-рекомбінаційним та інжекційним механізмами переносу
заряду.
Вступ
Матеріали
на основі з’єднань A2B6 та
належать до напівпровідникових матеріалів, інтерес до яких не зменшується вже
не один десяток років. Це пов’язано із їх фоторефрактивними властивостями
(CdTe), відносно високою радіаційною стійкістю та якісними оптичними
параметрами детекторів на його основі, які широко застосовуються для створення різноманітних оптичних приладів,
працюючих в ІЧ-області випромінювання.
Комерційне виробництво детекторів на їх основі з прийнятними для практичного застосування характеристиками відоме давно [1]. Проте проблеми, якими
супроводжується виготовлення таких детекторів,змушують розробників шукати нові технології створення поверхнево-бар’єрних
структур. До них, в першу чергу, слід
віднести методи створення фотодіодних структур лазерною перекристалізацією з
метою зміни типу провідності приповерхневого шару. Важливим також є питання
створення омічних контактів до вище перелічених структур, які характеризуються
малим шумом, мають лінійні, стабільні в часі вольт-амперні характеристики.
Постановка задачі досліджень
Застосування
лазерного випромінювання для модифікації поверхні зразків пов’язане із рядом
переваг в порівнянні з іншими методами зміни типу провідності та керування
концентрацією при поверхневих дефектів напівпровідника. По-перше, це обумовлено
короткою тривалістю процесу дії лазерного випромінювання на зразок, по-друге –
можливістю зміни параметрів матеріалів фотодіодних структур у широкому
діапазоні завдяки підбору необхідних значень енергій та довжин хвиль лазерного
променя, по-третє – універсальністю методу,
яка полягає у застосуванні лазера для створення як випрямляючих структур, так й омічних контактів до них
[2-4].
Особливості створення
поверхнево-бар’єрних фотодіодних структур на CdTe та Cd1-хMnхTe
Створення поверхнево-бар’єрних фотоструктур методом
лазерної перекристалізації проводилось на зразках з кристалів CdTe та Cd1-хMnхTe
(х = 0,2) n-типу провідності, вирощених методом Бріджмена [5].
Ці зразки володіли питомим
опором r = 0,83·102÷2,9·102 Ом∙см та рухливістю
носіїв заряду m = 983 і 470 см2/В×с для CdTe та Cd0,8Mn0,2Te, відповідно (Т = 300 К).
Їх обробка опроміненням проводилось на лазерній установці ГОР-100М, яка дозволяє одержувати одиночні
імпульси випромінювання на довжині хвилі λ = 0,694 мкм, сумарною енергією в імпульсі 100 Дж,
тривалість імпульсу складає 1,2 мс. Корегування густини випромінення, яким
оброблюється поверхня зразків, відбувалось шляхом зміни відстані між зразком та
фокусуючою лінзою. Опромінення мішеней з зразками проводилось в діапазоні
густини енергії 3÷10 Дж/см2, при цьому її контроль проводився
приладом ИКТ-1М.
Створення бар’єрних
структур відбувалось у вакуумній камері, що містила тримачі зразків та змінні
молібденові маски, які дозволяють задавати необхідні розміри та форму
опроміненої ділянки. Камера попередньо відкачувалась до тиску 10-5
тор, для уникнення окислення при проведенні процесів лазерної перекристалізації
поверхні зразків.

0251663360251659264251660288251661312Конструкція фотодіоду (рис.1)
складається з пластини СdTe n-типу
провідності (1), рекристалізованого лазерним випроміненням епітаксійного шару
СdTe p-типу провідності (2), омічних
контактів з In (3), електровиводів з Cu (4).
Механізм утворення бар’єрних структур у нашому
випадку полягає у збідненні приповерхневого шару легко летючим Cd, з наступним
утворенням кластерів Te [6]. Як відомо, вакансії Cd є
акцепторами для CdTe та Cd1‑xMnxTe, та ведуть до інверсії провідності проплавленого лазерним випромінюванням
епітаксійного шару з n-на p-тип.
Глибина залягання p-n переходу
визначалась за допомогою мікрофотографій поперечних сколів зразків, одержаних
на растровому електронному мікроскопі РЕМ-100У і складала від 8-12 мкм [7].
В
деяких випадках вищенаведені бар’єрні структури піддавались процесам лазерного
відпалу за технологією, яка наведена у [2]. Такий процес проводився за
допомогою одиночних імпульсів однієї з гармонік технологічного неодимового
лазера з hn < Eg матеріалу пластини. Це дозволяє зменшити величину оберненого струму
фотодіодів, які створюються.
Особливості виготовлення омічних
контактів
Омічні
контакти до структур на основі CdTe та його твердих розчинів створюються в декілька етапів, а їх технологія
визначалась із врахуванням типу провідності зразка, його питомого опору та
значенням роботи виходу електронів в контактних матеріалах. Лінійність їх
характеристик, в кінцевому рахунку, визначається якістю підготовки поверхні,
вибором матеріалів підконтактних площадок, типом флюсів та припоїв.
Створення
омічних контактів до низькоомних зразків р-CdTe (ρ≤104Ом∙см)
проводилось із використанням іскрової обробки контактних площадок для видалення
шару окислу [8]. Далі з розчинів AuHCl4 та CuSO4 на
підготовлену ділянку зразка послідовно осаджувались шари золота та міді,
відповідно[9]. Пайка мідних електровиводів (ø = 0,1 мм) до створених
контактних площадок проводилась In-Cu– припоєм (0,99 In + 0,01
Cu).
Слід
відмітити, що іскрова обробка поверхні зразків дозволяє зменшити на порядок
перехідний опір контакту, а також ще на порядок - безпосереднім нанесенням Cu
на підконтактну площадку з Au.
Застосування
іскрової обробки зразків р-CdTe (ρ>104Ом∙см) не дає
таких результатів. В цьому випадку створення контактів обмежується нанесенням
шару міді з подальшою пайкою мідних електровиводів In-Cu–припоєм.
Численні
технологічні експерименти та подальші дослідження показали, що омічні контакти
до низькоомного n-CdTe (ρ≤104Ом∙см) створюються
осадженням з водного розчину CuSO4 мідної контактної площадки та
пайкою до неї мідного електроду In-Cu припоєм (0,5In + 0,5Cu). Саме цей варіант використовувався для створення омічних контактів на наші підкладки n-типу.
Процес нанесення контактів
до високоомного n-CdTe (ρ>104Ом∙см) проводиться
аналогічно технології створення контактів високоомного матеріалу p-типу
провідності.
Як показали результати наших досліджень для підвищення
адгезій них властивостей контактних металевих шарів діодних структур на основі
p-CdTe або p-Cd1‑xMnxTe
(рис.1), процес іскрової обробки доцільно замінити лазерною [10].
Її особливість полягає в тому, що виникнення вакансій кадмію в цьому випадку не
призводить до інверсії провідності, а лише видаляє шар окислу. При цьому
рекомендується проводити лазерну проплавку разом із перехідною плівкою міді,
яка попередньо наноситься термічним напиленням на поверхню зразків р-CdTe та p-Cd1‑xMnxTe. Це дозволяє значно зменшити перехідний опір цих контактів [7].
Результати досліджень
електричних і фотоелектричних параметрів структур на основі CdTeта Cd1-xMnxTe
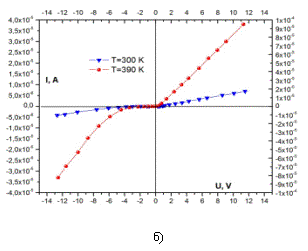
0
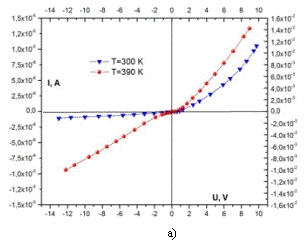
0На рис. 2 представлені
типові вольт-амперні характеристики структур на основі СdTe (а) та Cd0,8Mn0,2Te
(б) площею s=1,5 мм2,
одержані при Т=300К та 390К. При цьому їх коефіцієнт
випрямлення складає k » 104 та k » 30 та для СdTe таCd0,8Mn0,2Te, відповідно.
Рис.2. Вольт-амперні
характеристики поверхнево-бар’єрних структур: а) на основі CdTe;
б) на Cd0,8Mn0,2Te
Відсутність яскраво вираженої експоненційної
залежності при прямому зміщенні для структур на CdTe
та Cd0,8Mn0,2Te свідчить про наявність значного
послідовного опору Rs
випрямляючих структур. Аналіз температурної залежності ВАХ цих діодних структур
показує, що протікання струму в цьому випадку представляється відомою теорією
Саа-Нойслі-Шоклі [11] або її розгорнутою версію для асиметричних переходів, яку
запропоновував Чу [12].
Завдяки
великій швидкості лазерної рекристалізації проплавленого шару утворюється
різкий асиметричний p+-n перехід. Велика концентрація центрів
рекомбінації N в області просторового
заряду, а також висока інтенсивність генераційно-рекомбінаційних
процесів приводить до ситуації, коли розподіл носіїв заряду в цій області не є
квазіровноважним. Це значно ускладнює опис теоретичної моделі процесів
струмопереносу. В загальному випадку протікання струму в структурі описується
рівнянням:
 , (1)
, (1)
де Is – струм
насичення, n-діодний коефіцієнт.
При
малих напругах (U<1В) в
гомопереходах для напівпровідників з великою шириною забороненої зони Eg (Eg>Eg(Si)) рух зарядів через бар’єр
характеризується генераційно-рекомбінаційним механізмом [13]. Густина
генераційно-рекомбінаційного струму знаходиться інтегруванням U(x,V) по всій ділянці просторового
заряду:
![]() , (2)
, (2)
де S – площа
діоду, W-ширина ділянки просторового
заряду.
Концентрація електронів та дірок в ділянці
просторового заряду визначається виразами [14]:
 , (3)
, (3)
![]() , (4)
, (4)
де j (x,V) - розподіл
потенціальної енергії в області просторового заряду, який знаходиться з
рівняння:
![]() ,
(5)
,
(5)

де j0 - висота
потенціального бар’єру. На рис. 3 відсічка на осі напруг вказує значення
граничної напруги на бар’єрі, яка в нашому випадку дорівнює 0,9 В. З
Рис.3 Пряма вітка ВАХ структури
на СdTe
цього можна зробити висновок, що висота потенціального
бар’єру j0 для структур на СdTe дорівнює 0,9 еВ.
З аналізу прямих віток ВАХ у напівлогарифмічних
координатах Ln(I)=f(U) (рис.4) структур
основі СdTe встановлено, що мають місце
два механізми переносу заряду, зміна яких відбувається при напрузі U»
1,2 В. Першим механізмом є
генераційно-рекомбінаційний, а при напругах > 1В проявляється інжекційний
механізм. В умовах високого рівня інжекції рекомбінаційні центри знаходяться
приблизно посередині між рівнями Efn та Efp, а коефіцієнт
n в рівнянні (1) дорівнює 2. Такі
результати добре узгоджуються з теорією Чу.
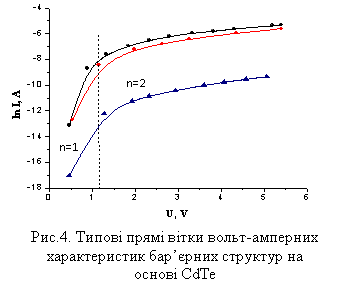
![]()
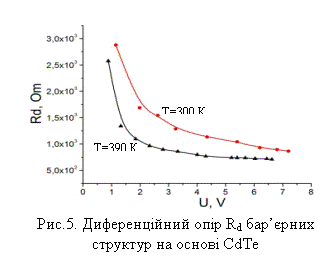 000251675648251674624 На
рис. 5 представлена залежність диференційного опору бар’єрних структур на СdTe
від прямої напруги. При прямій напрузі Uпр>5B спостерігається сублінійна залежність
диференційного опору, що дає можливість визначити послідовний опір Rs структури.
З даних рис. 5 встановлено, що його величина знаходиться в інтервалі Rs=(8,4-15,9)·102
Ом в залежності від температури.
000251675648251674624 На
рис. 5 представлена залежність диференційного опору бар’єрних структур на СdTe
від прямої напруги. При прямій напрузі Uпр>5B спостерігається сублінійна залежність
диференційного опору, що дає можливість визначити послідовний опір Rs структури.
З даних рис. 5 встановлено, що його величина знаходиться в інтервалі Rs=(8,4-15,9)·102
Ом в залежності від температури.
Дослідження фотоелектричних характеристик
фотодіодів проводилось на спектрофотометрі СФ-46. При цьому виявлено, що
структури на основі СdTe
володіють 2-ма максимумами фотовідгуку, які
відповідають значенням енергій 1,5 еВ та 1,44 еВ. У випадку структур на Cd0,8Mn0,2Te спостерігаються 3
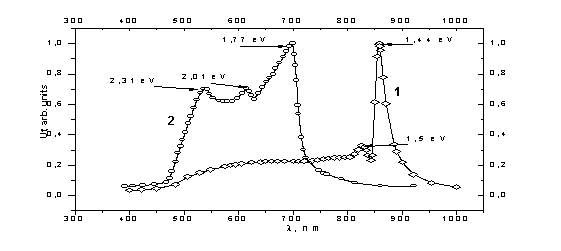
максимуми фоточутливості з енергіями - 2,31 еВ, 2,01 еВ та 1,77 еВ (рис.6).
Рис.6. Фотоелектричні
характеристики поверхнево-бар’єрних
структур:
1-
СdTe, 2 - Cd0,8Mn0,2Te
Додаткові піки, які не відповідають енергіям
власних переходів цих матеріалів, в цьому випадку зміщено у короткохвильову
ділянку спектру. Їх поява пояснюється утворенням гексагональних фаз CdTe
та MnTe обумовлених швидкою рекристалізації поверхневого шару зразків після дії
лазерного випромінення. Цей факт підтверджується також і результатами
досліджень кристалографічних параметрів плівок цих напівпровідникових
матеріалів, в яких встановлено одночасне існування двох кристалічних фаз із
різними зонними структурами [15].
Дослідження
спектральної фоточутливості Sλ фотодіодів на основі CdTe та
CdMnTe показали, що її значення знаходиться в діапазоні 0,38-0,43 А/Вт, що
дозволяє рекомендувати ці прилади для реального практичного застосування.
Висновки
Показано,
що існуючі лазерні технології дозволяють створювати інверсійні шари CdTe та Cd1‑xMnxTe, які характеризуються фоточутливістю в області спектру 0,5-0,91 мкм.,
проводити як очистку поверхні зразків, так й їх подальший лазерний відпал.
Запропонована
методика створення стабільних омічних контактів на структурах CdTe, Cd1‑xMnxTe
із застосуванням лазерної пасивації поверхні.
Встановлено,
що висота потенціально бар’єру j0 для структур на CdTe дорівнює 0,9 еВ, а протікання струму характеризується 2-ма механізмами переносу заряду –
генераційно-рекомбінаційним та інжекційним, їх коефіцієнт випрямлення складає k»104.
Спектральна
залежність фотовідгуку структур на основі CdTe та Cd1‑xMnxTe має додаткові максимуми, які зміщені в короткохвильову область і не пов’язані
із власними переходами. Їх спектральна чутливість в максимумі складає Sl=0,38-0,43
А/Вт.
Використана література
1. K.R. Zanio. Cadmium telluride. Semiconductors and semimetals (N.Y.,-
San Francisko - London, Acad. Press,1976) v. 13.
2.
Корбутяк Д.В., Ворощенко А.Т.,
Сукач А.В., Лоцько О.П., Демчина Л.А., Тетьоркін В.В. Спосіб виготовлення омічних контактів до високоомних
монокристалічних зразків p-CdТe, легованого хлором.- опис до патенту на корисну
моделель UA № 76097, 2012, 6 с.
3.
О.В. Галочкін, М.М. Рижук, Б.М. Грицюк, З.І. Захарук,
В.М. Стребежев, І.М. Раренко Бар'єрні структури на CdTe та Cd0,8Mn0,2Te,
отримані лазерною перекристалізацією поверхні. Науковий вісник Чернівецького
університету (2005) Випуск 268. Фізика. Електроніка. c. 54-56.
4.
A.I. Savchuk, B.M. Gritsyuk, O.V. Galochkin, M.M. Ryzhuk,
S.Y. Paranchich. Electrical, photoelectrical properties and crystal structure
of A2B6 films, grown by laser sputtering. Thin Solid
Films, Volumes 511-512, (2006), p. 478-482.
5. Ащеулов А.А., Воронка Н.К., Ильин В.И., Косенков Е.Н., Раренко И.М. Способ
получения кристаллов теллурида кадмия. Авторское свидетельство №1602839 СССР.,
заяв. 5.07.88.
6.
А. Байдулаева, А.И. Власенко, П.Е. Мозоль, А.Б. Смирнов
Состояние поверхности поликристаллических слоїв CdTe, облученных импульсным
лазерным излучением. ФТП, 35(6), с. 745-748 (2001).
7.
О.В. Галочкін, С.Г. Дремлюженко, Я.Д.Захарук, А.І.
Раренко, Є.В. Рибак, В.М. Стребежев. Дослідження поверхні і границі розділу
структур, сформованих на Cd1-хZnхTe и Cd1-хMnхTe
лазерною проплавкою//Фізика і хімія твердого тіла, 2003. Т. 4, №4.– с. 669-672.
8.
Е. С. Никонюк Физико-технологическое исследование примесных состояний в теллуриде кадмия:
Автореферат дис. на соискание ученой степени кандидата физико-математических
наук. (01.04.10) /Черновицкий гос. ун-т. - Черновцы, 1975. - 22 с.
9.
В.В. Слынько, Е.С. Никонюк, В.В. Матлак. Приборы и
техника эксперимента, № 3, 203 (1968).
10.
Корбутяк Д.В., Бобицький Я.В.,
Будзуляк С.І., Вахняк Н.Д, Демчина Л.А., Єрмаков В.М., Крилюк С.Г., Крюченко
Ю.В.Спосіб виготовлення детектора g- та Х- випромінювання на основі CdТe та
CdZnТe.- опис до деклараційного патенту
на винахід № UA46513, 2002, 6 с.
11.
Sah C.-T., Noyse R.N., Shokley W., - Proc. IRE, 1957, v.
45, N 9, p. 1228-1243.
12.
Choo, S. C. Solid-State Electron, (1968), V.11 (11),
p.1069-1077.
13.
Фаренбрух А., Бьюб Р. Солнечные элементы: Теория и
эксперимент/ Пер. с англ. под ред. М. М. Колтуна. -М.: Энергоатомиздат, 1987.
- 280 с.
14.
Л.А.Косяченко,И.М.Раренко, З.И.Захарчук, В.М.Склярчук,
Е.Ф.Склярчук, И.В.Солончук, И.С.Кабанова, Е.Л.Маслянчук Электрические свойства
поверхностно-барьерных диодов на основе CdZnTe. ФТП, 37, 238 (2003).
15.
A. RangaRao, V. Dutta, PhysicaStatusSolidi (a) 201 (2004)
P.72.