Технические науки / 6.Электротехника и радиоэлектроника.
д.т.н., проф. Осадчук
В.С., д.фіз.-мат.н., проф. Павлик Б.В.,
к.т.н., доц. Кравчук
Н.С., Осадчук Я.О.
Вінницький національний
технічний університет
Математична
модель фізичних процесів
у каналі МДН транзистора при дії температури з
урахуванням напруги зміщення на затворі
Використання
двозатворного польового транзистора як первинного перетворювача температури в
автогенераторному сенсорі температури з частотним виходом стимулює дослідження
термоіндукованих змін параметрів МДН структур на малому змінному сигналі. Проте
як свідчить аналіз літератури на сьогоднішній день недостатньо вивчені фізичні
механізми впливу температури на "електронно-діркову" плазму в
поверхневому шарі просторового заряду, відсутній аналітичний опис залежності
активної і реактивної складових імпедансу каналу від температури навколишнього
середовища. З появою двозатворних МДН структур ці питання набули ще більшої
актуальності, оскільки зазначені структури мають широкі функціональні
можливості в порівнянні з однозатворними. Розгляду цих питань присвячена дана
стаття.
Математична модель
фізичних процесів у каналі МДН транзистора при дії температури
Проведемо аналіз фізичних
процесів в ділянці каналу МДН транзистора. На фізичні процеси, що
відбуваються в каналі МДН структури, значною мірою впливають такі параметри, як
час прольоту носіїв через канал TR, час життя носіїв в каналі ![]() та стала
еквівалентного RC-кола, утвореного відповідними ємностями та опорами досліджуваної
структури
та стала
еквівалентного RC-кола, утвореного відповідними ємностями та опорами досліджуваної
структури ![]() [1].
[1].
Виходячи з результатів експерименту,
оцінимо вищеперераховані параметри та вплив на них температури. Схематично
досліджуваний транзистор можна представити, як показано на рис.1.

Рис.1. Схематичне зображення двозатворного МДН
транзистора
З рисунка видно, що такий транзистор можна розглядати як
два ідентичних однозатворних транзистори (стік першого транзистора умовно
з`єднано з витоком другого). Кожен із них представляє собою структуру, в якій
металевий затвор ізольовано від напівпровідника тонким шаром діелектрика
(рис.2).
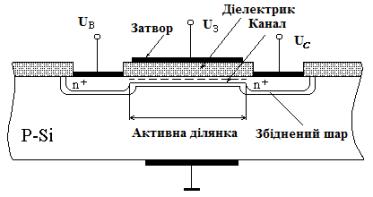
Рис. 2. Структура n – канального МДН транзистора
Рухливі носії в таких транзисторах знаходяться в
приповерхневій області напівпровідника, а їх концентрація залежить від
електричного поля, створюваного затвором (напругою на затворі), що істотно
відрізняє МДН прилади від транзисторів з керованим p-n- переходом. Поблизу n+-областей, що відповідають
витоку та стоку містяться області просторового заряду, що виникли за рахунок
внутрішньої різниці потенціалів на n+-p-переходах. Оскільки в
р-області електрони практично відсутні, опір ділянки "витік-стік"
досить високий і відповідає опору двох зустрічно ввімкнутих діодів при
нульовому зміщенні. Якщо ж до затвора прикладена додатна напруга, поблизу
поверхні відбувається інверсія типу провідності, так що в цій області
концентрація електронів стає достатньо високою і опір "витік-стік"
різко зменшується. Електрони починають рухатись від витоку до стоку по
інверсному шару.
Так, дійсно, при незмінній напрузі на затворі кожен із
транзисторів представляє собою структуру n+-p-n+-типу.
Тоді згідно [2] представлена структура опишеться рівнянням для малого сигналу
змінного струму:
![]()
![]() , (1)
, (1)
![]() , (2)
, (2)
де r1 – об'ємна густина
заряду при наявності змінного
електричного поля, r0 – об'ємна густина заряду при
відсутності змінного сигналу; J1 – швидкість носіїв заряду при
дії змінного електричного поля; J0 – аналогічно при його
відсутності; Є=e0e, де e0 – діелектрична стала, e – відносна діелектрична
проникність напівпровідникового матеріалу.
У виразі (1) перша компонента - модуляція густини заряду. Цей механізм
створює хвилі просторового заряду. Ці хвилі можуть розсіювати чи генерувати
енергію залежно від того, знаходяться
вони в фазі чи протифазі з локальним змінним електричним полем.
Друга компонента є відповідно модуляцією швидкості заряду і вона
представляє струм, який завжди перебуває у фазі з локальним електричним полем,
а, отже, призводить до розсіювання енергії.
Третя компонента відповідає струму зміщення, який не розсіює і не генерує
енергію. Ясно, якщо генерована енергія перевищує розсіяну - структура являє собою
високочастотний від'ємний опір. Зрозуміло, що малосигнальні характеристики
такої структури можуть бути отримані шляхом інтегрування (1) та (2) за
відповідних граничних умов. Ці умови можна задати, припускаючи, що n-область
має нескінченну провідність (для інжекції, обмеженої емісією). Обидва випадки
добре описані в літературі, але вони не досить точно відображають фізичні
процеси в реальних p-n переходах, оскільки не враховується одночасна
присутність як дифузійної так і дрейфової складових струму.
Розглянемо
відгук потенціального бар'єру на малу зміну електричного поля DE. Швидкість
носіїв заряду при цьому змінюється на DJ=m×DE, де m – рухливість
носіїв. Через деякий час встановлюється відповідний розподіл просторового
заряду в каналі польового транзистора, який буде існувати до відновлення
електронейтральності в ньому. Цей процес, пов'язаний з дифузією відбувається
повільно порівняно зі змінами DE. Отже, можна
припустити, що змінне поле малого сигналу модулює тільки швидкість носіїв
заряду, а не їх густину.
Розглянемо дві з існуючих моделей фізичних процесів, які відбуваються на
p-n переході: джерела, обмеженого просторовим зарядом та джерела, обмеженого
бар'єром. Перша ґрунтується на концепції нескінченної провідності, для якої
густина носіїв є нескінченно великою, електричне поле і швидкість носіїв заряду
нескінченно малі, а змінний струм малого сигналу являє собою модуляцію не
тільки густини, а й швидкості руху носіїв.
Друга характеризується скінченною густиною заряду і скінченною швидкістю їх
руху, а змінну складову струму можна розглядати як модуляцію швидкості руху
носіїв заряду.
На відміну від [2], де досліджувались діоди зі струмами, обмеженими
просторовим зарядом, в нашому випадку є необхідність розгляду обох вищезгаданих
моделей.
Модель джерела, обмеженого бар'єром. Так при напрузі на затворі U3, меншій за
граничну напругу Uгран,
каналу немає і тому досліджувана структура описується моделлю джерела,
обмеженого бар'єром. У цьому випадку імпеданс каналу може бути представлений
виразом [3]:
 , (3)
, (3)
де ![]()
![]() – густина струму
при відсутності змінного сигналу;
– густина струму
при відсутності змінного сигналу; ![]() ,
, ![]() – середня
швидкість носіїв заряду; TR
– час прольоту носіїв через канал; w – циклічна частота вхідного
сигналу; wD – частота діелектричної
релаксації;
– середня
швидкість носіїв заряду; TR
– час прольоту носіїв через канал; w – циклічна частота вхідного
сигналу; wD – частота діелектричної
релаксації; ![]() ,
, ![]() D – відповідні кути
прольоту (фазові кути);
D – відповідні кути
прольоту (фазові кути); ![]() –рухливість електронів, j=
–рухливість електронів, j=![]() ; NA
– концентрація акцепторів.
; NA
– концентрація акцепторів.
Як відомо з [4, 5], в точці інверсії знаку реактивності реактивна складова
імпедансу рівна нулю. Таким чином, виділивши в (3) уявну складову і прирівнявши
її до нуля, отримаємо вираз, з якого визначаємо частоту, що відповідає точці
інверсії знаку реактивності:
 . (4)
. (4)
Як видно з (4) wінв є, зокрема, функцією
часу прольоту ТR. В розглядуваному випадку (від'ємне зміщення на
затворах - канал відсутній) час прольоту можна розрахувати, виходячи з
наступних міркувань. Потужність на вході досліджуваного чотириполюсника
постійна і дорівнює P=10-6 Bт. Приймаючи до уваги [6], що ![]() , де
, де ![]() – активна
складова повного опору чотириполюсника, можна визначити напругу на вході
досліджуваного чотириполюсника
– активна
складова повного опору чотириполюсника, можна визначити напругу на вході
досліджуваного чотириполюсника ![]() . Середня
швидкість руху носіїв
v0C =Emn, тоді час проходження носіїв через канал польового
транзистора визначається як
. Середня
швидкість руху носіїв
v0C =Emn, тоді час проходження носіїв через канал польового
транзистора визначається як
 , (5)
, (5)
Модель джерела, обмеженого просторовим зарядом. При U3 >Uгран індукується канал, що відповідає
моделі джерела, обмеженого просторовим зарядом. Згідно [3] імпеданс можна
представити:
 . (6)
. (6)
Аналогічно попередньому випадку, виходячи з (6) виділимо уявну складову
імпедансу і прирівнявши її до нуля визначимо частоту, що відповідає точці
інверсії знаку реактивності:
 . (7)
. (7)
Згідно [7] час прольоту
для цього випадку можна представити як

де UПОР – відповідає напрузі на затворі, при якій утворюється
канал.
Дане рівняння дає дещо завищене значення часу прольоту, так як UHAС – це така напруга
"затвор-витік", при якій
струм в каналі досягає насичення. Оскільки постійне зміщення в колі "затвор-витік" відсутнє, то
час прольоту можна визначити за формулою (5).
Проведемо якісний аналіз результатів, отриманих згідно вищерозглянутих
моделей і зіставлення їх з експериментальними результатами. Як видно з (4) та
(7) частота, що відповідає точці інверсії знаку реактивності, є функцією часу
прольоту ТR та частоти
діелектричної релаксації wD. Оскільки час прольоту ТR та частота діелектричної
релаксації wD є функціями рухливості mn (3 та 5), яка, в свою
чергу, залежить від температури, то можна вважати, що частота інверсії також є
функцією температури. Відомо [8], що
рухливість носіїв mn в ділянці каналу з підвищенням температури
падає в зв’язку з посиленням різних механізмів розсіювання. В інтервалі
температур від -55 0С до 125
0С залежність рухливості від
температури можна представити у вигляді
m ~ 1/T як для дірок так і для
електронів. Аналіз співвідношень (4), (7) показує, що частота інверсії wінв ~ mn, тому, виходячи зі сказаного вище, випливає наступне: з
підвищенням температури значення частоти, що відповідає точці інверсії знаку
реактивності зсувається в область більш низьких частот, що узгоджується з експериментальними
дослідженнями авторів [5, 8].
При від’ємних
зміщеннях на затворах МДН транзистора канал відсутній, а тому досліджувана
структура може бути представлена еквівалентним RC-колом (рис.3). Відсутність у
приведеній еквівалентній схемі дифузійної ємності пов’язано з тим, що на
високих частотах бар’єрна ємність шунтує дифузійну, оскільки Сд ~ ( wtд ) -1/2, тобто зі збільшенням частоти Сд
зменшується [9].
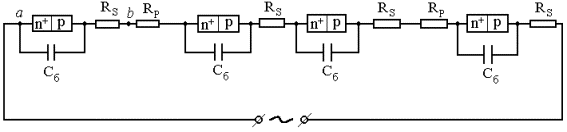
Рис.3.
Представлення двозатворного МДН транзистора
еквівалентним
RC-колом
Припустимо,
що р-n переходи являються ідеальними вентилями, де Rs – опір втрат [9], Rp
– опір р-ділянок. Тоді на частоті w опір Rпр між
точками а і b рівний Rs, а  , і тоді умова Rзв/Rпр
>>1 ~ wсRsCб матиме вигляд:
, і тоді умова Rзв/Rпр
>>1 ~ wсRsCб матиме вигляд:
 . (8)
. (8)
Оцінювання сталої часу RC-кола. Виходячи з технологічних параметрів, розрахуємо сталу tRC = RsCб. При умові, що Rs « Rр, розрахунки ємності (n+-р) переходу та опору Rр проводимо згідно [9].
Ємність р-n
переходу в загальному випадку визначається виразом для площинного конденсатора:
 ,
(9)
,
(9)
де e = eneo = 11,8·8,85·10-14
Ф/см = 1,0443·10-12 Ф/см – діелектрична проникність кремнію, А – площа р-n переходу, W – ширина ділянки об’ємного заряду.
Для випадку, коли
розподіл концентрації домішок по обидві сторони від переходу є рівномірним,
ширина збідненого шару визначається за формулою:
 , (10)
, (10)
де Vj – спад напруги на переході, для якого справедливо
співвідношення Vj=j+UR, j – контактний
потенціал, рівний ~0,8 В, UR – напруга, прикладена до
переходу;
 .
(11)
.
(11)
Тоді
 . (12)
. (12)
Для симетричного переходу будемо мати:
 ,
,  . (13)
. (13)
Враховуючи,
що j » UR (для випадку наших досліджень),
отримаємо:
 . (14)
. (14)
Визначимо
величину ємності р-n переходу на основі (14) за відомими значеннями:
А = 1,2 мкм · 0,14 мкм = 1,2·10-4·1,4·10-5
(см2);
NА = 1017см -3;
q = 1,6·10-19 Кл; j = 0,8 В;
e = 1,0443·10-12 Ф/см.
Розрахунки показали, що Cj = 1,69·10-16
Ф.
Розрахунок Rp проводимо, виходячи з геометричних розмірів р-області
та питомого опору матеріалу ділянки згідно даних технологічної картки за
загальновідомою формулою R=r.l / S. В результаті розрахунку отримаємо:
Rp = 4,8·105 Ом.
Таким чином,
для однієї ланки (Сб, Rp) еквівалентного RС-кола
досліджуваної МДН структури стала часу
матиме значення:
![]() .
.
Таке значення сталої відповідає
частоті:
 МГц.
МГц.
Висновки
Для опису фізичних процесів у каналі
двозатворного польового транзистора запропоновано використовувати як модель
джерела, обмеженого просторовим зарядом, так і модель джерела, обмеженого
бар'єром. На основі цих моделей отримано аналітичні вирази для частот інверсії
знаку реактивності повного опору каналу. Показано, що частота інверсії
зменшується при зростанні температури за рахунок залежності часу прольоту
носіїв заряду через канал та частоти діелектричної релаксації від температури.
При від'ємних опорах на затворах досліджувану МДН структуру можна описати
ланцюгом еквівалентних RC-кіл, розраховано сталу часу для однієї ланки ланцюга,
що складає 8,064·10-11 с.
Література:
1.
Осадчук
В.С., Яремчук В.Ф., Кравчук Н.С. Дослідження впливу температури на інерційні
властивості “електронно-діркової плазми” в каналі МДН-структури // Вісник ВПІ.
– 1998. – №4. – С. 82–85.
2.
Jager
D., Heidemann R., Kassing R. Influence of Carrier Transit Time on Small-Signal
Admittance of SCLC Diodes // Physica Status Solidi. – 1977. – Vol. 42. – P.
657– 665.
3.
G.T.Wright.
Small-Signal characteristics // Solid State Electroniks. – 1973. – Vol. 16, –
№8. – P. 903– 912.
4.
Одобецкий
С.И., Осадчук В.С. Современное состояние и перспективы развития
полупроводниковых частотных датчиков неэлектрических величин. Часть 1.
Теоретические предпосылки использования реактивных свойств полупроводниковых
структур в контрольно-измерительной технике / Винницкий политехн. ин-т. –
Винница, 1988. – 20 с. – Рус. – Деп. в УкрНИИНТИ 05. 01. 88, – № 70 – Ук88.
5.
Осадчук
О.В. Мікроелектронні частотні перетворювачі на основі транзисторних структур з
від’ємним опором. –Вінниця: «Універсум-Вінниця», 2000. – 303 с.
6.
Справочник
по радиоизмерительным приборам. Под ред. В.С. Насонова. – Т. 2. – М.: Сов.
Радио, 1977. – 272 с.
7.
Ржевкин
К.С. Физические принципы действия полупроводниковых приборов. – Изд- во Мос.
Ун- та, 1986. – 257 с.
8.
Осадчук
В.С., Осадчук О.В., Вербицький В.Г. Температурні та оптичні мікроелектронні
частотні перетворювачі. – Вінниця: УНІВЕРСУМ-Вінниця, 2001. – 195 с.
9.
Викулин
И.М., Стафеев В.И. Физика полупроводниковых приборов. –М.: Радио и связь, 1990.
–264 с.